CORIAL
Corial 200I

- Установка реактивно-ионного травления и травления индуктивно связанной плазмой для НИОКР и аналитических лабораторий
- Для травления применяются химические соединения фтора и кислорода
- Применяется для травления: кремния и кремнийсодержащих соединений (SiO2, Si3N4); полимеров (полиметилметакрилата, полиимида, бензоциклобутена, фоторезиста); металлов (Ti, TiN, TiW, W, Ta, TaN, Nb, Mo и других)
- Подложки/пластины различных размеров (например: 7 х 2”) вплоть до1 х 8”
Corial 200ML

- Установка ECR / Микроволнового травления плазмой высокой плотности с ручной загрузкой и вакуумным загрузочным шлюзом
- Смесь CH4/H2 и хлорсодержащие реакционные газы применяются для травления двойных – четверных полупроводниковых соединений А3В5 и А2В6: GaN, GaAs, GaP, GaAlAs, InP, InGaAsP, ZnS, CdTe и HgCdTe
- Загрузка: от 7 пластин Ø2″ до 1 – Ø200мм
- 220-мм подложкодержатель (электрод); гелиевое охлаждение обратной стороны подложкодержателя обеспечивает температуру пластины < 100°C
Corial 200R

- Установка реактивно-ионного травления для НИОКР и прототипирования с прямой загрузкой (опционно – через загрузочный шлюз)
- Для травления применяются химические соединения фтора
- Применяется для травления: кремния и кремнийсодержащих соединений (SiO2, Si3N4); полимеров; металлов (Ge, W, Ta, TaN, Ti, TiN, TiW, Nb, NbN, Mo)
- Подложки/пластины различных размеров: от небольших частей пластин до целых пластин Ø200мм
Corial 200FA

- Установка реактивно-ионного травления для лабораторий анализа отказов с ручной загрузкой:
— изотропное (1500 нм/мин) удаление полиимида глубиной до 5000 нм,
— изотропное (700 нм/мин) и анизотропное (500 нм/мин) удаление Si3N4,
— изотропное и анизотропное (250 нм/мин) удаление SiO2,
- Размер пластины — до Ø200мм
- Технология разряда в системе с полым катодом
- Гелиевое охлаждение обратной стороны подложкодержателя
Corial 200S

- Установка реактивно-ионного травления для НИОКР
- Применяется для травления: кремния и кремнийсодержащих соединений (SiO2, Si3N4) глубиной до 500 нм и скоростью травления 120 нм/мин для Si и более 70 нм/мин для Si3N4; полимеров (полиимида, бензоциклобутена, фоторезиста); металлов (Au, Pt, Fe, Cu, PZT, Ti, TiN, TiW, W, Ta, TaN, Ge, Nb, NbN, Mo). При травлении Ta обеспечивается профиль травления более 85° и скоростью травления более 90 нм/мин
- Подложки/пластины различных размеров: от небольших частей пластин до целых пластин ø8”
- 220-мм подложкодержатель (электрод), гелиевое охлаждение обратной стороны подложкодержателя
Corial 210RL

- Установка реактивно-ионного травления для НИОКР
- Загрузка через вакуумный загрузочный шлюз
- Для травления применяются химические соединения фтора и хлора
- Обширная встроенная библиотека стандартных процессов: травление с фторсодержащими газами кремния и кремнийсодержащих соединений (SiO2, Si3N4), металлов (Ge, W, Ta, TaN, Ti, TiN, TiW, Nb, NbN, Mo), полимеров; травление с хлорсодержащими газами полупроводниковых соединений А3В5 и А2В6 (GaN, AlGaN, GaAs, InP), металлов (Al, Cr, Ti)
Corial 210IL

- Установка травления индуктивно-связанной плазмой / реактивно-ионного травления для НИОКР и мелкосерийного производства оптоэлектроники, МЭМС, силовой электроники, ИС для телекоммуникации, интегральной оптики и прочих
- Ручная загрузка через вакуумный загрузочный шлюз с электромагнитным приводом: от 1 x 2” до 7 x 2”, от 1 x 3” до 3 x 3”, 1 x 4”, 1 x 6”, 1 x 8”
- Для травления применяются химические соединения фтора и хлора
- Применяется для травления: кремния и кремнийсодержащих соединений (SiO2, Si3N4, SiC); полимеров (полиметилметакрилата, полиимида, бензоциклобутена, фоторезиста); полупроводниковых соединений А3В5 (GaN, AlGaN, InP) и А2В6 (ZnS, CdTe, HgCdTe); металлов (Al, Cr, Au, Ni, Fe, Pt, Cu, Ti, TiN, TiW, W, Ta, TaN, Ge, Nb, NbN, Mo); соединений повышенной твердости (Al2O3, SiC, LiTaO3, стекла, кварц, сапфир)
Corial 210D

- Низкотемпературная установка осаждения диэлектриков и травления в высокоплотной индуктивно связанной плазме для НИОКР и специализированного производства (ИС для телекоммуникации, современные сборочные операции и прочих)
- Вакуумный загрузочный шлюз с устройством перемещения пластин и малым временем откачки
- В процессах применяются химические соединения фтора и хлора
- Загрузка: пластины от 1 x 2” до 7 x 2”, от 1 x 3” до 3 x 3”, 1 x 4”, 1 x 6”
Corial D250

- Установка высоко- и низкотемпературного плазмостимулированного осаждения для мелкосерийного производства и специализированного применения (оптоэлектроника, МЭМС, силовая электроника, ИС для телекоммуникации, интегральная оптика)
- Прямая загрузка (опционно – вакуумный загрузочный шлюз с устройством перемещения пластин и малым временем откачки)
- Изотермальный реактор, 260-мм подложкодержатель (электрод)
- Загрузка: пластины от 1 x 2” до 11 x 2”, от 1 x 3” до 3 x 3”, 2 x 4”, 1 x 6”, 1 x 8”
Corial D250L

- Установка высокотемпературного плазмостимулированного осаждения для мелкосерийного производства и специализированного применения (оптоэлектроника, МЭМС, силовая электроника, ИС для телекоммуникации, интегральная оптика)
- Ручная загрузка через вакуумный загрузочный шлюз с электромагнитным устройством перемещения пластин и малым временем откачки)
- Изотермальный реактор, 260-мм подложкодержатель (электрод)
- Загрузка: пластины от 1 x 2” до 11 x 2”, от 1 x 3” до 3 x 3”, 2 x 4”, 1 x 6”, 1 x 8”
Corial PS200
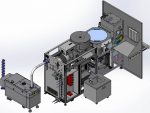
- Кластерная четырехмодульная установка серийного производства и специализированного применения
- Полностью автоматизированная кассетная загрузка с использованием вакуумного робота и подъемного устройства для кассет с механическим зажимом или электростатическим держателем (опционно) пластин
- Может объединять до трех процессных модулей с технологиями RIE (реактивно ионное травление), ICP-RIE (травление индуктивно связанной плазмой — реактивно ионное травление) или PECVD (плазм стимулированное осаждение из газовой фазы) серий Corial 200 (Corial 210RL, Corial 210IL, Corial D250)
- Транспортировочный модуль создан на базе вакуумного робота Brooks MagnaTran® 7 (MAG 7) для точного, надёжного и автоматизированного перемещения пластин
Corial 300S

- Установка реактивно-ионного травления для НИОКР и производства фотошаблонов, МЭМС и прочих
- Ручная загрузка: шаблоны от 2” x 2” до 8” x 8”; возможна групповая обработка пластин 7 x 4” и 3 x 6”
- Для травления применяются химические соединения фтора
- Применяется для травления: хрома и кварца при изготовлении фотошаблонов; кремния и кремнийсодержащих соединений (SiO2, Si3N4, Si); полимеров (полиимида, бензоциклобутена, фоторезиста); металлов (Au, Pt, Fe, Cu, PZT, Ti, TiN, TiW, W, Ta, TaN, Ge, Nb, NbN, Mo)
Corial 300IL

- Установка травления индуктивно-связанной плазмой / реактивно-ионного травления для НИОКР и мелкосерийного производства
- Ручная загрузка через вакуумный загрузочный шлюз с роботизированным электромагнитным приводом: до 19 x 2”, до 7 x 4”, до 3 x 6”, до 1 — Ø300мм
- Для травления применяются химические соединения хлора
- Применяется для травления: GaN, сапфира
Corial 360RL

- Установка реактивно-ионного травления для производства фотошаблонов, МЭМС и оптоэлектроники
- Ручная загрузка через вакуумный загрузочный шлюз: шаблоны от 2” x 2” до 8” x 8”; возможна групповая обработка пластин 7 x 4” и 3 x 6”
- Для травления применяются химические соединения фтора и хлора
- Применяется для травления: хрома и кварца при изготовлении фотошаблонов; кремния и кремнийсодержащих соединений (SiO2, Si3N4, Si); полимеров (полиимида, бензоциклобутена, фоторезиста); металлов (Au, Pt, Fe, Cu, PZT, Ti, TiN, TiW, W, Ta, TaN, Ge, Nb, NbN, Mo); полупроводниковых соединений А3В5 (GaAs, GaP, GaN, AlGaN)
Corial 360IL

- Установка травления индуктивно-связанной плазмой / реактивно-ионного травления для специального полупроводникового производства: оптоэлектроники, МЭМС, приборов силовой электроники и прочих
- Загрузка через вакуумный загрузочный шлюз с устройством перемещения: до 23 x 2”, до 7 x 4”, до 3 x 6”
- Для травления применяются химические соединения фтора и хлора
- Применяется для травления: кремния и кремнийсодержащих соединений (SiO2, Si3N4, Si); полупроводниковых соединений А3В5 (GaN, AlGaN, GaP), сапфира
Corial D350

- Установка высокотемпературного плазмостимулированного осаждения для производства изделий специализированного применения (фотоника, оптоэлектроника, МЭМС)
- Изотермальный реактор с вакуумной камерой и оригинальным распылителем
- Прямая загрузка — одиночные пластины до 300 мм, либо групповая загрузка, например: 27 x 2”
- Применяется для плазмостимулированного осаждения: aSi-H, SiO2, Si3N4, SiC, SiOCH, SiOF
Corial D350L

- Установка высокотемпературного плазмостимулированного осаждения для производства изделий специализированного применения (фотоника, оптоэлектроника, МЭМС)
- Изотермальный реактор с вакуумной камерой и оригинальным распылителем
- Загрузка через вакуумный загрузочный шлюз — одиночные пластины до 300 мм, либо групповая загрузка, например: 27 x 2”
- Применяется для плазмостимулированного осаждения: aSi-H, SiO2, Si3N4, SiC, SiOCH, SiOF
Corial 400L

- Установка реактивно-ионного травления
- Ручная загрузка через роботизированный вакуумный загрузочный шлюз: подложки 14″ х 14″
- Для травления применяются химические соединения фтора и хлора
- Применяется для травления: металлов, полимеров и Si соединений
Corial D500 PECVD

- Высокопроизводительная установка плазмостимулированного осаждения для крупносерийного производства изделий специализированного применения (приборы силовой электроники, оптоэлектроника, МЭМС)
- Изотермальный реактор с вакуумной камерой и оригинальным распылителем
- Групповая загрузка: 104 x 2”, 25 x 4”, 9 x 6”, 4 x 8”
- Применяется для плазмостимулированного осаждения: aSi-H, SiO2, Si3N4, SiC, SiOCH, SiOF
