PLASMA-THERM
VERSALINE ICP/RIE

- Установка травления материалов в индуктивно-связанной плазме от НИОКР до крупносерийного производства.
- Подложки размером: 8х2”, 4х3”, одиночные от 3” до 8”
- Варианты загрузки: загрузка через шлюз (одиночные пластины или партия); кассетная загрузка пластин или образцов
- Библиотека стандартных технологических процессов травления: GaN, GaAs, AlGaP, InP, InGaAs, HgCdTe; SiC, Al2O3; Si, SiO2, SiNx; Cr, Ti, Al, TiN, TiW, Mo;
VERSALINE DSE

- Установка глубокого травления кремния от НИОКР до серийного производства МЭМС, динамических ОЗУ
- Подложки размером до 8”
- Варианты загрузки: загрузка через шлюз; кассетная загрузка пластин или образцов
- Библиотека стандартных технологических процессов травления: Si, SiO2, Si3N4, SiOxNy; полиметилметакрилат, фоторезист, полиимид
VERSALINE PECVD

- Установка плазмостимулированного осаждения из газовой фазы для крупносерийного производства
- Подложки размером до 8”
- Варианты загрузки: прямая ручная загрузка; загрузка через шлюз (одиночные пластины или образцы); кассетная загрузка пластин или образцов
- Библиотека стандартных технологических процессов осаждения: диэлектриков (SiO2, SiNx, SiOxNy); полупроводников (SiC, a-Si)
VERSALINE HDPCVD

- Установка низкотемпературного плазмохимического осаждения из газовой фазы от НИОКР до серийного производства с применением высокоплотной плазмы
- Подложки размером от 3” до 8”
- Варианты загрузки: загрузка через шлюз (одиночные подложки); кассетная загрузка пластин
- Библиотека стандартных технологических процессов осаждения: диэлектриков (SiO2, SiNx, SiOxNy); полупроводников (SiC, a-Si)
Singulator MDS-100, MDS-300

- Установки плазменного разделения пластин на кристаллы для крупносерийного производства, обладающие серьезными преимуществами по сравнению со стандартной технологией скрайбирования для тонких и сверхтонких пластин: гладкие боковые стенки кристаллов, отсутствие боковых повреждений, повышение прочности кристаллов, ширина реза 10 мкм и менее, возможность разделения пластин толщиной менее 50 мкм, разделение непрямоугольных кристаллов (со скругленными углами, клиновидной формы и т.д.)
- Использование стандартных в скрайбировании несущей ленты с пластиковыми или металлическими каркасами
- Загрузка двух кассет, до 25 каркасов с пластинами в каждой
- Непрерывный процесс для 4”, 6”, 8” пластин на 8” каркасе (MDS-100) и 12″ пластин на 12″ каркасе (MDS-300)
Pinnacle

- Установки ионнолучевого травления и осаждения представляют из себя однокамерные модули с реакторами ионнолучевого травления или осаждения, объединяющие в одном кластере от одного до трех модулей травления, осаждения или комбинации модулей травления и осаждения
- Высокая производительность за счет ионных источников большой площади и усовершенствованной системы перемещения
- Квалифицированы для применения в 200-мм производстве. Предназначена для обработки 200-мм пластин, 150-мм пластин и 9,5” ячеек, может модифицироваться для обработки 300-мм пластин
LAPECVD

- Установка плазмостимулированного осаждения из газовой фазы на большие поверхности для крупносерийного производства
- Подложки: максимальная загрузка при групповой обработке – 3 пластины по 8”
- Варианты загрузки: кассетная загрузка пластин
- Возможность групповой обработки большого количества пластин, применение парных кассет (работа из кассеты в кассету)
Versalock

- Кластерная установка с загрузкой «из кассеты в кассету» выпускалась в следующих конфигурациях: ICP, RIE, DSE™, PECVD и HDPCVD
700 VLR (Versalock ) PECVD
- Установка плазмостимулированного осаждения из газовой фазы
- Подложки размером 4” (возможность использования для 8”)
- Содержит модули LM/TM и PECVD
ORBIS™ Alpha™

- Установка для травления в среде XeF2 и HF оксидов и кремния при изготовлении МЭМС для НИОКР
- Применяется для изготовления датчиков, ВЧ МЭМС, микроболометров, температурных датчиков, микроакселерометров, ВЧ-переключателей
- Применение XeF2 эффективно для травления различных материалов, включая SiO2 и Si3N4, HF наиболее эффективен при травлении Si3N4
- Подложки размером до 200 мм
ORBIS™ 1000
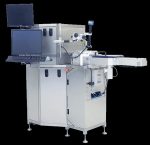
- Установка для автоматизированного травления в среде XeF2 и HF оксидов и кремния при изготовлении МЭМС для мелкосерийного производства
- Применяется для изготовления датчиков, ВЧ МЭМС, микроболометров, температурных датчиков, микроакселерометров, ВЧ-переключателей
- Применение XeF2 эффективно для травления различных материалов, включая SiO2 и Si3N4, HF наиболее эффективен при травлении Si3N4
- Пластины размером 100, 125, 150, 200 мм, а также различные типы других подложек и образцов
ORBIS™ 3000

- Полностью автоматизированная кластерная установка для изготовления МЭМС в крупносерийном производстве
- Содержит до трех процессных модулей, поддерживающих технологии травления XERIX и нанесения покрытий AURIX
- Применяется для изготовления датчиков, ВЧ МЭМС, микроболометров, температурных датчиков, микроакселерометров, ВЧ-переключателей
- Применение XeF2 эффективно для травления различных материалов, включая SiO2 и Si3N4, HF наиболее эффективен при травлении Si3N4
Mask Etcher Series

- Установка для производства фотошаблонов высокого разрешения с применением технологии индуктивно-связанной плазмы.
- В зависимости от модификации установки позволяет получать элементы с топологическим размером менее: 1 – 250нм, 2 – 180нм, 3 – (130÷90)нм, 4 – (65÷45)нм, 5 – (32÷ 22)нм
- Варианты загрузки: автоматизированная загрузочная станция; загрузка пластин из SMIF-контейнера через буферную зону
- Имеется возможность применять Cr, MoSi, кварц, ультрафиолетовое облучение, импринтные технологии
Odyssey HDRF

- Установка обработки пластин в индуктивно-связанной плазме с технологией HDRF от НИОКР до крупносерийного производства
- Технология HDRF (High Density Radical Flux) полностью исключает ионную составляющую процесса травления, что позволяет избежать внесение электрического заряда в полупроводниковую структуру.
- Модификации: от лабораторной однокамерной установки с ручной загрузкой до промышленных установок с двумя загрузочными шлюзами и двумя процессными камерами. Однокамерная установка может быть модернизирована в двухкамерную. Двухкамерная установка может быть сконфигурирована для односторонней или двусторонней обработки пластин
- Подложки размером до 8”
Navigator™ 6

- Установка с технологией HDRF плазменного удаления фоторезиста, очистки поверхности пластин от органических загрязнений и удаления промежуточного полимерного слоя при изготовлении МЭМС и для применения в микроэлектронном производстве
- Технология HDRF (High Density Radical Flux) полностью исключает ионную составляющую процесса травления, что позволяет избежать внесение электрического заряда в полупроводниковую структуру.
- Предназначена для групповой обработки пластин, но может быть использована и для обработки одиночных пластин
- Ручная загрузка пластин
Navigator™ 8

- Установка с технологией HDRF плазменного удаления фоторезиста, очистки поверхности пластин от органических загрязнений и удаления промежуточного полимерного слоя при изготовлении МЭМС и для применения в микроэлектронном производстве
- Технология HDRF (High Density Radical Flux) полностью исключает ионную составляющую процесса травления, что позволяет избежать внесение электрического заряда в полупроводниковую структуру.
- Предназначена для групповой обработки пластин, но может быть использована и для обработки одиночных пластин
- Ручная загрузка пластин
VERSALINE RIE

- Установка реактивно-ионного травления плазмой от НИОКР до крупносерийного производства. Возможна модернизация для процессов травления индуктивно-связанной плазмой
- Подложки размером: 8х2”, 4х3”, одиночные от 3” до 8”
- Варианты загрузки: прямая ручная загрузка (одиночные пластины или партия); загрузка через шлюз (одиночные пластины или партия); кассетная загрузка пластин или образцов
- Библиотека стандартных технологических процессов травления
