Carl Zeiss AG
Zeiss AIMS™ 1x-193i

Система анализа качества масок
- Даже малейшие дефекты компоновки одного фотошаблона могут привести к огромным потерям при экспонировании чипов на пластине. Вот почему так важно проверить все маски на наличие дефектов, понять их влияние на процесс фотолитографии и устранить их до того, как маска будет использована в степпере или сканере. Наилучший способ надежного контроля качества на этом этапе — оптическая имитация
- AIMS™ 1x-193i это уникальная система проверки масок, используемая предприятиями изготавливающими фотошаблоны для проверки дефектов и анализа возможности их использования. Система позволяет пользователю оценивать оптические характеристики маски в условиях эквивалентных сканеру.
Zeiss AIMS™ 32x-193i

Система анализа качества масок
- Даже малейшие дефекты компоновки одного фотошаблона могут привести к огромным потерям при экспонировании чипов на пластине. Вот почему так важно проверить все маски на наличие дефектов, понять их влияние на процесс фотолитографии и устранить их до того, как маска будет использована в степпере или сканере. Наилучший способ надежного контроля качества на этом этапе — оптическая имитация фотолитографического процесса с использованием метода аэрофотосъемки (AIMS™).
- Система AIMS ™ является единственным в мире эмулятором сканера, охватывающим все методы литографии, включая двойное структурирование, оптимизацию исходной маски (SMO) и обратную литографию.
Zeiss MeRiT® HR II

Система восстановления масок
- Фотомаски с нулевыми дефектами печати важны для изготовления высококачественных интегральных схем на заводских подложках. Поскольку размеры постоянно уменьшаются, требования и затраты, связанные с этими ключевыми оптическими элементами, возрастают в геометрической прогрессии, и с ними возникает необходимость ремонта дефектного изделия.
- Новый инструмент для ремонта фотошаблона высокого разрешения MeRiT® HR II предлагает более высокую степень автоматизации и более широкий спектр дополнительных опций ремонта, чем было доступно ранее. Модернизированная система позволяет восстанавливать прозрачные и непрозрачные дефекты любой геометрии на всех известных типах масок, таких как Binary, OMOG, HD MoSi и EUV.
Zeiss WLCD
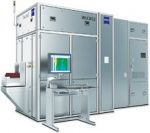
Система метрологического анализа масок
- Система метрологического контроля критических размеров и фазового сдвига на уровне пластин
- С уменьшением топологических размеров возрастает роль метрологического контроля кристаллов. По этой причине мы предоставляем системы для контроля критических размеров, фазового сдвига на уровне пластин, каждая из которых может быть измерена в области активного дизайна.
- WLCD измеряет критический размер (CD) на фотомасках в условиях освещения, соответствующих сканеру, с высокой пропускной способностью. Проверенная технология «аэрофотосъемки» используется для оценки качества печати маски.
Zeiss PROVE® Compact

Система метрологического анализа масок
- Высокоразрешающая метрологическая система
- Идеальное размещение изображений, измерения критических размеров и фазовый контроль.
- С уменьшением топологических размеров возрастает роль метрологического контроля кристаллов. По этой причине мы предоставляем системы для контроля критических размеров, фазового сдвига на уровне пластин, каждая из которых может быть измерена в области активного дизайна.
- Система PROVE® Compact выполняет метрологический и overlay контроль для фото масок с повторяемостью и точностью до нанометров и в соответствии текущими и перспективными требованиями к размещению шаблона.
Zeiss CDC32

Промышленная система финальной доводки масок
- Продвинутый контроль критических размеров
- Значительно улучшает равномерность критических размеров (CDU)
- Одним из ключевых параметров, необходимых для обеспечения функциональности любой интегральной схемы, является единообразие критических размеров (CDU). Существуют различные факторы, которые влияют на общий CDU, такие как единообразие критических размеров маски, влияние сканера и линзы, резистивные профессы, топография пластины, коэффициент усиления ошибки маски (MEEF).
Zeiss RegC®
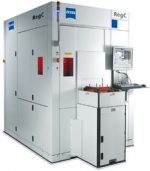
Система финальной доводки маски
- Новое поколение метрологического контроля критических размеров и совмещения
- Значительно улучшает равномерность CD
- Одним из ключевых параметров, необходимых для обеспечения функциональности любой интегральной схемы, является единообразие критических размеров (CDU). Существуют различные факторы, которые влияют на общий CDU, такие как единообразие критических размеров маски, влияние сканера и линзы, резистивные профессы, топография пластины, коэффициент усиления ошибки маски (MEEF).
Zeiss MERLIN

Растровый электронный микроскоп
- Ускоряющее напряжение: 0,02-30 кВ
- Разрешение до 0.8нм для не прозрачных образцов и 0.6нм (в режиме просвечивающего микроскопа)
- Образец 6″ на 5-координатной подвижке
- уникальной электронной колонной GEMENI II позволяет работать как с экстремально низкими ускоряющими напряжениями, так и с очень высокими токами пучка
Zeiss Auriga CrossBeam

Двухлучевой электронный микроскоп (FIB-SEM)
- Растровый электронный микроскоп с колонной фокусированных ионных пучков (ФИП) совмещает в себе возможности 3D визуализации и аналитические возможности электронного пучка.
- Пространственное разрешение до 1нм с электронной колонной и до 2.5нм с ионной
- Размер образца до 6″. Размер камеры Ø 520мм, высота 307мм
- Диапазон ускоряющих напряжений 0,1 — 30 kВ
Zeiss Xradia 810 Ultra

Рентгеновский промышленный микроскоп
- Уникальное разрешение до 50нм (при увеличение 800x) в лабораторных условиях без использования синхротронного излучения
- Неразрушающая система трехмерной визуализации с помощью рентгеновского излучения позволяет получать повторные изображения одного и того же образца при различных условиях
- Размер образца 12х10х12мм
- Переключаемое поле зрения в диапазоне от 15 до 60 мкм
