FHR Anlagenbau
FHR.Star.300 (PVD)
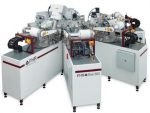
- Многоцелевая кластерная установка для создания в условиях вакуума тонкопленочных функциональных покрытий (проводящих, изолирующих, барьерных, адгезионных, оптических) на пластинах (подложках) в полупроводниковой промышленности, производстве МЭМС, солнечных элементов и датчиков, микроэлектронике, оптоэлектронике, оптике (НИОКР или мелкосерийное производство)
- Может содержать до 6 модулей, связанных между собой вакуумным перегрузчиком: загрузки-разгрузки (2), плазмостимулированного (PE) или реактивно-ионного (RIE) травления, магнетронного напыления (DC или RF способ), термического или электронно-лучевого испарения, плазмоактивированного химического осаждения из газовой фазы (PECVD), атомно-слоевого осаждения (ALD), быстрого лампового отжига (FLA), быстрых термических процессов (RTP) – конфигурация по заданию заказчика
- Размер подложек: диаметром от 50 до 200 мм, толщиной до 15мм
- Температурный контроль подложки и держателя
FHR.Flash.50-Module

- Модуль ультракороткого импульсного отжига в условиях вакуума или в среде рабочего газа
- Применение: отжиг и плавление материалов в миллисекундном диапазоне
- Подложкодержатель для подложек диаметром до 100 мм (опционно – 250 мм)
- Количество импульсных ламп: 8 шт.
FHR.Micro.100-RIE

- Лабораторная установка реактивно-ионного травления
- Назначение: травление подложек / слоев Si, a-Si, SiNx, SiOx, фоторезиста и прочих для предочистки и формирования изображения
- Подложкодержатель с фиксаторами для подложек диаметром до 100 мм
- Ручная загрузка-выгрузка подложек
FHR.Micro.150-MonoEVA

- Лабораторная установка термического напыления
- Назначение: термическое напыление меди (Cu), галлия (Ga), индия (In), селена (Se) и прочих материалов
- Подложкодержатель с фиксаторами для подложек диаметром до 150 мм
- Ручная загрузка-выгрузка подложек
FHR.Micro.150-DuoPVD

- Лабораторная установка магнетронного напыления с двойным источником
- Назначение: динамический процесс напыления при комнатной температуре проводящих материалов – хрома (Cr), меди (Cu), золота (Au), серебра (Ag) и прочих металлов с использованием DC-источника; напыление непроводящих материалов – оксида алюминия (Al2O3), диоксида кремния (SiO2) при опционном использовании RF-источника
- Процессная камера из алюминия
- Вращающийся подложкодержатель для подложек размером до диаметра 200 мм
FHR.Micro.150-PECVD

- Лабораторная установка плазмостимулированного химического осаждения из газовой фазы
- Назначение: осаждение слоев a-Si, SiNx, SiOx, SiOxNy, алмазоподобных углеродных покрытий и прочих
- Подложкодержатель с фиксаторами для подложек диаметром до 100 мм
- Ручная загрузка-выгрузка подложек
FHR.Micro.160-FLA

- Лабораторная установка ультракороткого импульсного отжига в условиях вакуума или в среде рабочего газа для полупроводникового производства, оптики, МЭМС
- Применение: восстановление поверхности, отжиг пластиков (низкотемпературных материалов), сушка фотолаков и пленочных покрытий, уплотнение пленочных покрытий, изменение параметров пленок
- Подложкодержатель с фиксаторами для подложек диаметром до 100 мм (опционно – 250 мм)
- Количество импульсных ламп: 8 шт.
FHR.Micro.160-IBE-RIE

- Лабораторная установка ионно-лучевого и реактивно-ионного травления
- Назначение: травление меди (Cu), кремния ( Si), галлия (Ga) и прочих материалов
- Возможность вращения и наклона подложкодержателя с подложками диаметром 4”
- Ручная загрузка-выгрузка подложек
FHR.Micro.200-ALD

- Установка термического и плазмостимулированного атомно-слоевого осаждения Al2O3, TiO2 и прочих соединений
- Подложкодержатель с фиксаторами для подложек диаметром до 200 мм
- Ручная загрузка-выгрузка подложек
- Температура процесса: до 400°C
FHR.Micro.200-PVD

- Лабораторная установка магнетронного напыления тонких пленок в вакууме для НИОКР и обучения
- Размер подложек: диаметром до 200 мм, толщиной до 30мм (более 30 мм с использованием проставочных колец)
- Ручная загрузка-выгрузка подложек
- Модификации установки:
— DC модель: осаждение электропроводящих слоев (Al, нержавеющая сталь, Cr, Cu, Au, Ag и прочих);
— HF модель: осаждение электропроводящих или неэлектропроводящих слоев (Al2O3, SiO2, ZrxOy, Si3N4 и прочих)
FHR.Micro.300-Clean

- Лабораторная установка плазменной предочистки
- Назначение: проведение процессов предочистки кислородной плазмой
- Подложкодержатель с фиксаторами для подложек размером 300 x 300 мм
- Ручная загрузка-выгрузка подложек
FHR-Star300BOX (PVD)

- Установка предназначена для нанесения металлов на различные поверхности
- Объем загрузки: до 24 подложек размером 60×48 мм
- Ручная загрузка-выгрузка подложек через дверь в фронтальной части установки
- Рабочая камера из нержавеющей стали диаметром 800 мм
FHR.Boxx.400-PVD
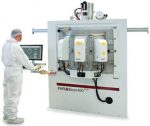
- Однокамерная установка магнетронного напыления на различные подложки с предподготовкой поверхности (плазменное травление) для мелкосерийного производства датчиков, МЭМС, оптических изделий
- Максимальный размер подложки: диаметром 150 мм или 156 x 156 мм
- Объем групповой загрузки: до 24 пластин размером 4″, до 12 подложек размером 6″
- Ручная загрузка-выгрузка подложек через дверь в фронтальной части установки на вращающийся барабан (опционно – через загрузочный шлюз)
FHR ALD 100
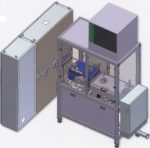
- Установка атомно-слоевого осаждения со специальными газовыми линиями
- Применяется для осаждения тонкопленочных оксидов (HfO₂, Al₂O₃, La₂O₃, SiO₂ и прочих), нитридов (TiN, TaN, SiNx и прочих), металлов (W, Ta, Cu, Ru и прочих)
- Пластины: до Ø100 мм
- Нагрев подложки: до 600°C
FHR ALD 150

- Установка атомно-слоевого осаждения
- Применяется для осаждения тонкопленочных оксидов (HfO₂, Al₂O₃, La₂O₃, SiO₂ и прочих), нитридов (TiN, TaN, SiNx и прочих), металлов (W, Ta, Cu, Ru и прочих)
- Подложки Ø150 мм, объемные образцы 20 мм (до 100 слоев)
- Ненагреваемая камера загрузки-разгрузки из алюминия, загрузка по1 подложке в боксе с ламинарным потоком
FHR ALD 300
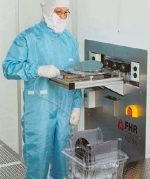
- НИОКР двухреакторная установка атомно-слоевого осаждения
- Применяется для осаждения тонкопленочных оксидов (HfO₂, Al₂O₃, La₂O₃, SiO₂ и прочих), нитридов (TiN, TaN, SiNx и прочих), металлов (W, Ta, Cu, Ru и прочих)
- Подложки Ø150, 200, 300 мм
- Ручная загрузка по одной пластине, чистая комната внутри установки
FHR ALD 300
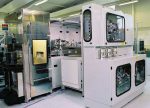
- Промышленная двухреакторная установка атомно-слоевого осаждения
- Применяется для осаждения тонкопленочных оксидов (HfO₂, Al₂O₃, La₂O₃, SiO₂ и прочих), нитридов (TiN, TaN, SiNx и прочих), металлов (W, Ta, Cu, Ru и прочих)
- Подложки Ø300 мм
- Фабричная загрузка с 2 портами для стандартных кассет на 25 пластин
FHR MS120-FLA

- Модуль ультракороткого импульсного отжига в условиях вакуума или в среде рабочего газа для кластерной установки
- Размер подложек: пластины диаметром до 120 мм, с использованием адаптера: 4”, 3”, 2”, а также подложки прямоугольной или иной формы
- Подложкодержатель: хромоникелевая кассета с кварцевыми фиксаторами
- Роботизированное устройство перемещения пластин
FHR FLA 100-DL
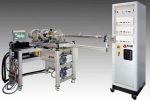
- Составная лабораторная установка импульсного отжига в условиях вакуума и среде рабочего газа
- Размер подложек: пластины диаметром 4”, с использованием адаптера – 3”, 2”, а также подложки прямоугольной или иной формы
- Подложкодержатель: хромоникелевая кассета с кварцевыми фиксаторами
- Герметизированное витоном устройство перемещения пластин
FHR FLA 100

- Установка импульсного отжига в условиях вакуума и среде рабочего газа с максимальной температурой процесса до 2000°C
- Размер подложек: пластины диаметром 4”, с использованием адаптера – 3”, 2”, а также подложки прямоугольной (20 х 30 мм, толщиной до 1 мм) или иной формы
- Подложкодержатель: кварцевая шайба с кварцевыми фиксаторами
- Горизонтальное перемещение подложкодержателя с использованием носителя с магнитным приводом
FHR FLA 200-A
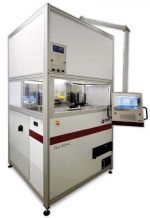
- Установка импульсного отжига в среде рабочего газа с максимальной температурой процесса до 1500°C
- Размер подложек: пластины диаметром 8”, с использованием адаптера: 4”, 3”, 2”, а также подложки прямоугольной или иной формы
- Подложкодержатель: алюминиевая шайба с кварцевыми фиксаторами
- Роботизированное устройство перемещения пластин
