FHR Anlagenbau
FHR.Star.100-TetraCo (PVD)
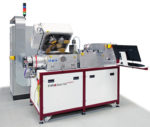
- Кластерная установка для создания в условиях вакуума тонкопленочных покрытий для НИОКР и пилотного производства.
- Назначение: нанесение многослойных пленок для МЭМС и датчиков, функциональных покрытий для микро- и оптоэлектроники, силовых приборов
- Реализуемые процессы: реактивное и инертное магнетронное распыление (режим постоянного тока); предварительная обработка (например, плазменное травление); соосаждение на вращающийся держатель подложки
- Состав: загрузочный шлюз, транспортировочная камера, процессная камера
FHR.Star.150-Co (PVD)

- Кластерная установка для создания в условиях вакуума тонкопленочных покрытий для НИОКР и пилотного производства.
- Назначение: нанесение многослойных пленок для МЭМС и датчиков, функциональных покрытий для микро- и оптоэлектроники, силовых приборов
- Состав: загрузочный шлюз, транспортировочная камера, 2 процессные камеры (для высоко- и низкотемпературных процессов)
- Подложки: до ø200 мм и толщиной (0,8÷5,0) мм
FHR.Star.220 (PVD)
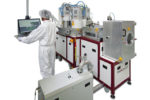
- Универсальная кластерная установка для создания в условиях вакуума толстых и тонких пленочных покрытий для НИОКР и серийного производства.
- Назначение: нанесение многослойных оптических пленок, функциональных покрытий для МЭМС и датчиков
- Реализуемые процессы: реактивное и инертное магнетронное распыление (ВЧ-режим); предварительная обработка (например, плазменное травление)
- Состав: загрузочный шлюз, транспортировочная камера с вакуумным манипулятором, процессная камера
FHR.Star.300 (PVD/ALD)

- Многоцелевая кластерная установка для создания в условиях вакуума тонкопленочных функциональных покрытий (проводящих, изолирующих, барьерных, адгезионных, оптических) на пластинах (подложках) в полупроводниковой промышленности, производстве МЭМС, солнечных элементов и датчиков, микроэлектронике, оптоэлектронике, оптике для промышленного производства
- Назначение: нанесение высококачественных оптических пленок, функциональных покрытий для МЭМС, датчиков, силовых приборов на карбиде кремния
- Камеры кассетной загрузки-разгрузки: 2
- Транспортировочная камера свосемью портами и вакуумным манипулятором-перегрузчиком
FHR ALD 100 (ALD)
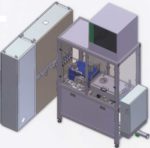
- Установка атомно-слоевого осаждения для НИОКР и пилотного производства
- Назначение: для осаждения тонкопленочных оксидов (HfO₂, Al₂O₃, La₂O₃, SiO₂ и прочих), нитридов (TiN, TaN, SiNx и прочих), металлов (W, Ta, Cu, Ru и прочих)
- Пластины: до ø100 мм
- Нагрев подложки: до 600°C
FHR ALD 150 (PEALD)

- Установка плазмостимулированного атомно-слоевого осаждения для НИОКР и пилотного производства
- Назначение: для осаждения тонкопленочных оксидов (HfO₂, Al₂O₃, La₂O₃, SiO₂ и прочих), нитридов (TiN, TaN, SiNx и прочих), металлов (W, Ta, Cu, Ru и прочих)
- Подложки: пластины ø150 мм; объемные подложки: 20 мм, до 100 слоев
- Загрузка по1 подложке в боксе с ламинарным потоком
FHR ALD 300 НИОКР (ALD)
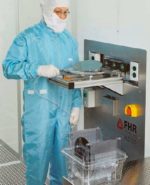
- Двухреакторная установка атомно-слоевого осаждения для НИОКР
- Назначение: для осаждения тонкопленочных оксидов (HfO₂, Al₂O₃, La₂O₃, SiO₂ и прочих), нитридов (TiN, TaN, SiNx и прочих), металлов (W, Ta, Cu, Ru и прочих)
- Подложки: пластины ø150, 200, 300 мм
- Ручная загрузка по одной пластине, зона загрузки – в чистой комнате
FHR ALD 300 (ALD)
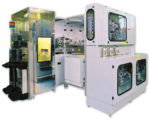
- Двухреакторная установка атомно-слоевого осаждения для промышленного производства
- Применяется для осаждения тонкопленочных оксидов (HfO₂, Al₂O₃, La₂O₃, SiO₂ и прочих), нитридов (TiN, TaN, SiNx и прочих), металлов (W, Ta, Cu, Ru и прочих)
- Подложки ø300 мм
- Система автоматической загрузки с азотным охлаждением и с 2 портами для стандартных кассет на 25 пластин
FHR-Star300BOX (PVD)

- Однокамерная установка магнетронного напыления металлов на различные поверхности
- Объем загрузки: до 24 подложек размером 60×48 мм
- Ручная загрузка-выгрузка подложек через дверь в фронтальной части установки
- Рабочая камера из нержавеющей стали диаметром 800 мм
FHR.Boxx.400-PVD (PVD)
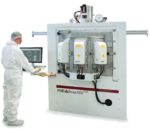
- Однокамерная установка магнетронного напыления для мелкосерийного производства
- Назначение: нанесение оптических пленок на осветительные приборы, функциональных покрытий для МЭМС и датчиков, декоративных покрытий, многослойных покрытий
- Реализуемые процессы: магнетронное напыление (постоянным током или ВЧ-режим); предварительная обработка (например, плазменное травление)
- Подложки: пластины до ø150 мм или подложки до 156 x 156 мм
FHR.Micro.150-MonoEVA (PVD)

- Лабораторная установка термического напыления
- Назначение: термическое напыление Cu, Ga, In, Se и прочих материалов
- Подложкодержатель с фиксаторами для подложек до ø150 мм
- Ручная загрузка-выгрузка подложек
FHR.Micro.150-DuoPVD (PVD)

- Лабораторная установка магнетронного напыления с двумя источниками
- Назначение: динамический процесс напыления при комнатной температуре проводящих материалов – Cr, Cu, Au, Ag и прочих металлов с использованием DC-источника; напыление непроводящих материалов –Al2O3, SiO2 при опционном использовании RF-источника
- Процессная камера из алюминия
- Вращающийся подложкодержатель для подложек размером до ø200 мм
FHR.Micro.160-IBE-RIE (IBE)

- Лабораторная установка ионно-лучевого и реактивно-ионного травления
- Назначение: травление Cu, Si, Ga и прочих материалов
- Возможность вращения и наклона подложкодержателя с подложками ø4”
- Ручная загрузка-выгрузка подложек
FHR.Micro.200-ALD

- Установка термического и плазмостимулированного атомно-слоевого осаждения Al2O3, TiO2 и прочих соединений
- Подложкодержатель с фиксаторами для подложек до ø200 мм
- Ручная загрузка-выгрузка подложек
- Температура процесса: до 400°C
FHR.Micro.200-PVD (PVD)

- Лабораторная установка магнетронного напыления тонких пленок в вакууме для НИОКР и обучения
- Подложки: до ø200 мм толщиной до 30мм (более 30 мм — с использованием проставочных колец)
- Ручная загрузка-выгрузка подложек
- Модификации установки:
— DC модель: осаждение электропроводящих слоев (Al, нержавеющая сталь, Cr, Cu, Au, Ag и прочих);
— HF модель: осаждение электропроводящих или неэлектропроводящих слоев (Al2O3, SiO2, ZrxOy, Si3N4 и прочих)
