NAURA
Esther E320R

- Установка газофазной эпитаксии для выращивания кремниевых эпитаксиальных структур при пониженном давлении для НИОКР и массового производства
- Назначение: для проведения объемной эпитаксии кремния, эпитаксии скрытого слоя и селективной эпитаксии при производстве интегральных схем, силовых полупроводников и пр.
- Подложки: пластины ø8’’
- Обработка: по одной пластине
- Состав установки: модуль системы передачи, модуль технологической камеры, модуль контроля давления и т. д.
- Модуль переноса совместим с пластинами различных размеров
- Система управления установкой: точный контроль давления, температуры, распределения газовых потоков
- Опционно: по запросу клиента – установки с одной и несколькими камерами
Esther E320A

- Установка газофазной эпитаксии для выращивания кремниевых эпитаксиальных структур при атмосферном давлении для НИОКР и массового производства
- Назначение: для выращивания эпитаксиальных кремниевых слоев N-типа и P-типа при производстве интегральных схем, силовых полупроводников и пр.
- Подложки: пластины ø5’’, ø6’’, ø8’’
- Обработка: по одной пластине
- Состав установки: два порта загрузки, модуль системы передачи, модуль технологической камеры, модуль управления, система инфракрасного нагрева, система вращательного подъема и т. д.
- Модуль переноса совместим с пластинами различных размеров
- Система управления установкой: система контроля температуры инфракрасного нагрева, система распределения газовых потоков
- Опционно: по запросу клиента – установки с одной и несколькими камерами
Eris E120R

- Установка газофазной эпитаксии для выращивания кремниевых эпитаксиальных структур при пониженном давлении для НИОКР и массового производства
- Назначение: для проведения эпитаксии скрытого слоя, селективной эпитаксии и поликристаллической эпитаксии при производстве интегральных схем, силовых полупроводников и пр.
- Подложки: пластины ø6’’, ø8’’
- Обработка: по одной пластине
- Состав установки: модуль системы передачи, модуль технологической камеры, модуль контроля давления и т. д.
- Модуль переноса совместим с пластинами различных размеров
- Система управления установкой: точный контроль давления, температуры, распределения газовых потоков
Eris E120A

- Установка газофазной эпитаксии для выращивания кремниевых эпитаксиальных структур при атмосферном давлении для НИОКР и серийного производства
- Назначение: для выращивания эпитаксиальных кремниевых слоев при производстве силовых полупроводников и пр.
- Подложки: пластины ø5’’, ø6’’, ø8’’
- Обработка: по одной пластине
- Состав установки: модуль системы передачи, модуль технологической камеры, модуль контроля давления, система инфракрасного нагрева, система вращения, система охлаждения и т. д.
- Модуль переноса совместим с пластинами различных размеров воздушного потока
- Система управления установкой: система контроля температуры инфракрасного нагрева, пятизонное поле распределения газовых потоков и др.
Hesper E230A
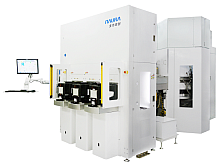
- Установка газофазной эпитаксии для выращивания кремниевых эпитаксиальных структур при атмосферном давлении для НИОКР и массового производства
- Назначение: для выращивания эпитаксиальных кремниевых слоев N-типа и P-типа при производстве силовых полупроводников, интегральных схем и др.
- Подложки: пластины ø12’’
- Обработка: по одной пластине
- Состав установки: три загрузочных порта; высокоскоростной робот-переносчик; одна, две или четыре технологических камеры (по запросу заказчика); система инфракрасного нагрева и т. д.
- Система управления установкой: многозонная система контроля температуры инфракрасного нагрева, многоканальная система распределения газовых потоков
SES Series

- Установка газофазной эпитаксии для выращивания кремниевых эпитаксиальных структур для НИОКР и массового производства
- Назначение: для выращивания эпитаксиальных кремниевых слоев N-типа и P-типа при производстве силовых полупроводников, легированных полупроводниковых подложек и пр.
- Подложки: пластины4 ø5’’, ø6’’, ø8’’
- Обработка: групповая (по несколько пластин в процессе)
- Толщина выращиваемых эпитаксиальных слоев: (5÷150) мкм
- Состав установки: два порта загрузки, модуль системы передачи, технологическая камера с несколькими подложкодержателями, система управления, система индукционного нагрева и т. д.
- Автоматизированная система управления установкой: система распределения газовых потоков, система блокировок
MARS iCE115

- Установка газофазной эпитаксии для выращивания эпитаксиальных структур карбида кремния (SiC) для НИОКР и серийного производства
- Назначение: для выращивания эпитаксиальных слоев карбида кремния N-типа и P-типа при производстве сложных полупроводниковых структур, легированных полупроводниковых подложек и др.
- Подложки: пластины ø4’’, ø6’’
- Обработка: по одной пластине
- Технология горизонтальной горячей стены.
- Возможность многослойной эпитаксии – совместимость с тонкопленочными и толстопленочными процессами эпитаксии
- Система управления установкой: система контроля давления, система контроля температуры, система смешанного газового потока и др.
