EVATEC AG
Evatec CLUSTERLINE 200 II (PVD/HIS PVD/PECVD)
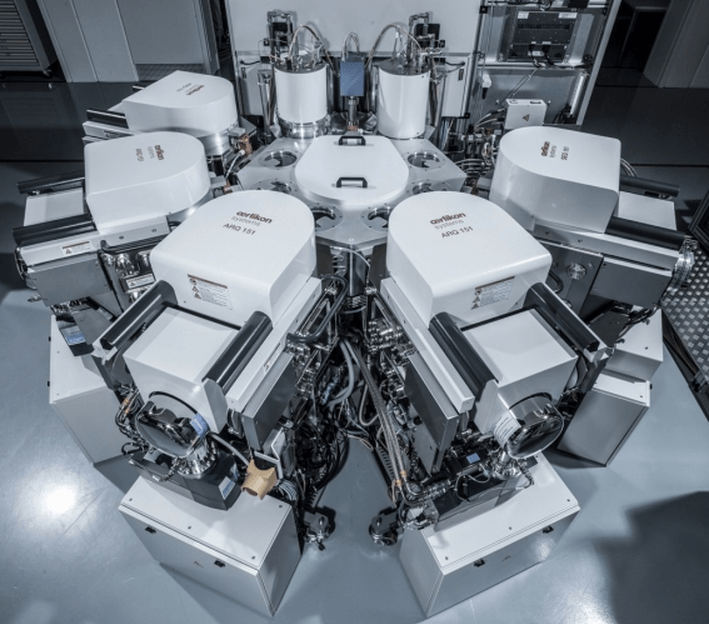
- Кластерная установка для магнетронного напыления, высокоионизированного физического осаждения из газовой фазы, мягкого травления и плазмоактивированного химического осаждения из газовой фазы от НИОКР до прототипирования и массового производства
- Назначение: изготовление пьезоэлектрических приборов (слои AlN, AlScN, ZnO, Ti-Mo, Ti-Pt, Al, Al-сплавы, W, SiO2, Si3N4 и т.д.), пакетных сборок (слои Ti-Cu, TiW-Cu, TiW-Au, TiW(N)-Au, Ti-NiV-Cu, Al-NiV-Cu, TaN, SiCr, NiFe и т.д.), металлизация обратной стороны пластин ( слои Al-Ti-NiV-Ag, Ti-NiV-Ag/Au, Cr-Ni-Ag/Au, AuAs-Ag-NiV-AgGe и т.д.), светодиодов (SiNx, SiOxNy), МЭМС, тонкопленочных головок, солнечных элементов, наноструктур и т.д.
- Кластер содержит до 6-ти различных модулей
- Конфигурации: для обработки одиночных пластин применяются Single Process Modules (SPM); для групповой обработки пластин – Batch Process Module (BPM)
- Подложки ø4″, ø5″, ø6″, ø8″ толщиной от 70 мкм до 6 мм
- Групповая единовременная обработка: до (20+1) подложек ø6“; до (15+1) подложек ø8”
- Температура подложкодержателя контролируется в диапазоне (-30 ÷ +800)°C
- Двухкасетный шлюз для загрузки и выгрузки пластин без контакта с оператором
- Вспомогательный модуль обеспечивает выравнивание пластины, промежуточное хранение, дегазацию, охлаждение, идентификацию
- Роботизированная система переноса магнитным способом
- Плоские магнетроны (до 4-х магнетронных источников постоянного тока и ВЧ на одном кластерном модуле с возможностью одновременной работы) с вращающейся магнитной системой
- Мягкий процесс ICP травления с обработкой подложек плазмой H2, N2 и O2
- Программно управляемые вакуумирование и вентиляция
- Площадь размещения кластера: 3800 x 4200 мм
Evatec CLUSTERLINE 300 II(PVD/HIS PVD/ICP)

- Кластерная промышленная установка для для магнетронного напыления, высокоионизированного физического осаждения из газовой фазы, мягкого травления при массовом производстве
- Назначение: изготовление пакетных сборок (слои Ti-Cu, TiW-Cu, TiW-Au, TiW(N)-Au, Ti-NiV-Cu, Al-NiV-Cu, TaN, SiCr, NiFe и т.д.), металлизация обратной стороны пластин / проведения процессов на утоненных пластинах ( слои Al-Ti-NiV-Ag, Ti-NiV-Ag/Au, Cr-Ni-Ag/Au, AuAs-Ag-NiV-AgGe и т.д.)
- Подложки: ø200 или ø300 мм толщиной от 300 мкм до 4 мм
- Температура подложкодержателя контролируется в диапазоне (-30 ÷ +500)°C
- Кластер содержит до 6-ти процессных модулей и две кассетные загрузочные станции
- Модуль PVD оснащается источником распыления постоянного или импульсного постоянного тока
- Мультиисточники с вращающимся держателем – до 4-х источников ВЧ или постоянного тока на одном модуле для одиночной мишени или одновременного распыления.
- Модули загрузки с загрузочными портами для 300 мм FOUP или открытых кассет для 200 мм пластин
Показать больше- Станция переворота пластины для металлизации обратной стороны пластины и буферная станция на объем до 12-ти пластин
- Роботизированная система переноса магнитным способом с двухсторонними двусимметричными манипуляторами. Опционно: робот SCARA с 3÷5 степенями подвижности
- Сверхточное позиционирование пластины с автоматической корректировкой в условиях вакуума. Выравнивание пластины по углу поворота 0,3°, центрирование – 0,05 мм
- Модуль ИСП-травления позволяет обеспечить высокую скорость и однородность травления. Возможны процессы с использованием H2, N2 и O2
- Использование ИСП модуля для удаления SiO2 со скоростью (0,6÷0,8) нм/сек
- Площадь размещения кластера: 4500 x 5300 мм
Evatec CLUSTERLINE RAD (PVD/HIS PVD/ ICP)

- Кластерная установка для автоматизированных групповых процессов напыления, дегазации/травления при производстве светодиодов, МЭМС, изделий радиосвязи и фотоэлектроники
- Назначение: изготовление высокочастотных приборов на соединениях А3В5 (биполярных транзисторов с гетеропереходом на GaAs, сверхскоростных транзисторов на GaN, ВЧ-фильтров и т.д.), оптических МЭМС, датчиков, переключателей, миниатюрных и сверхярких светодиодов, ИК-приборов, фотоэлектрических модулей, лазеров и т.д.
- Кластер содержит до 4-х напылительных модулей и один модуль дегазации/травления
- Подложки ø2″, ø4″, ø5″, ø6″, ø8″
- Прямая кассетная загрузка пластин или подложек осуществляется через сдвоенный загрузочный шлюз на лицевой стороне установки и обеспечивает быструю перестройку системы под разные размеры подложек
- Четыре источника магнетронного напыления и один источник травления
- Применение технологии вращающейся мишени для высоких скорости нанесения и однородности оптических интерфереционных покрытий
- Мониторинг плазменной эмиссии (PEM) для корректировки стехиометрии в процессе осаждения оксидов
- Рабочее давление – <5·е-7 мбар
- Площадь размещения: кластера – 3200 x 3800 мм, кластера и стойки управления — 4200 x 3800 мм
Evatec Radiance (PVD/ICP)
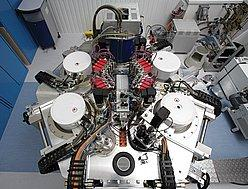
- Многофункциональная кластерная платформа напыления для одиночной или групповой обработки подложек при производстве сложных оптических пакетов в фотонике, сверхярких светодиодов, прецизионной оптики и оптических МЭМС
- Назначение: осаждение металлов, токопроводящих оксидных слоев и диэлетриков для изготовления оптических фильтров, просветляющих покрытий, оптических МЭМС, фотоэлектрических датчиков, сверхярких светодиодов, силовых приборов, приборов беспроводной связи, металлизации пластин, тонких пленок головок, ПАВ и т.д.
- Подложки: до ø200, вариант – ø300
- Конфигурации:
— Одиночный модуль для НИОКР с однопластинной обработкой (SPM) и ручной загрузкой по одной пластине обеспечивает напыление от одного или нескольких источников и мягкое травление.
— 8-торонняя кластерная платформа с присоединением до 6-ти модулей с однопластинной обработкой (SPM) и вакуумной кассетной автоматической загрузкой обеспечивает напыление от одного или нескольких источников, мягкое травление, дегазацию (опционно – PECVD и RIE);
— 4-хсторонняя кластерная платформа с присоединением до 2-х модулей с групповой обработкой пластин (BPM), включающие до 4-х станций напыления, 1 модуля дегазации / травления и вакуумной кассетной автоматической загрузкой;
— 4-хсторонняя комбинированная кластерная платформа с присоединением до 2-х модулей с однопластинной обработкой (SPM) и 1 модуля с групповой обработкой пластин (BPM) и вакуумной кассетной автоматической загрузкой обеспечивает напыление от одного или нескольких источников, динамическое напыление, мягкое травление, дегазацию.
- Вариант загрузки: до 25 пластины ø100 мм, до 18 пластины ø150 мм, до 13 пластины ø200 мм, или до 10 квадратных подложек 150 х 150 мм
- Для кластерных конфигураций: транспортный модуль с роботом и вакуумным элеватором, кассетная транспортировка, модули загрузки и разгрузки
- Температура подложкодержателя: SPM – до 850°C; BPM – до 350°C
- Система охлаждения подложкодержателя
- Скорость вращения подложкодержателя: SPM – (0÷300) об/мин; BPM – (0÷200) об/мин
- Расстояние от распыляемой мишени до подложки: регулируемое – до 135 мм
- Базовое давление: SPM – < 8,0 х 10-8 мбар; BPM – < 2,0 х 10-7 мбар
- До 4-х процессных газов и сжатый воздух
- Компьтерное управление на базе Windows XP (стойка управления)
- Высокопроизводительная вакуумная система: турбомолекулярные и форвакуумные насосы
- Компрессор
- Термостатирование камеры: SPM – >60°C; BPM – >80°C
- Площадь размещения кластера: SPM – 3500 x 3000 мм; BPM – 3200 x 3500 мм
- Электроэнергия (вариант): 400В, 3ф, 50Гц, 100А
- Опционно: ВЧ–напряжение смещения на подложкодержателе; оптический пирометр для мониторинга и контроля температуры
Evatec HEXAGON (PVD/ICP)

- Кластерная промышленная установка напыления на одиночные пластины для многоуровневой сборки, металлизация обратной стороны пластин, дегазаци и мягкого травления ИСП
- Подложки ø200 или ø300 мм
- Кластер содержит до 5 процессных модулей и два загрузочных модуля
- Модули загрузки с загрузочными портами для 300 мм FOUP или открытых кассет для 200 мм пластин
- Температура подложкодержателя контролируется в диапазоне от -30°C до 300°C
- Подложкодержатель: металлический или керамический с механическим зажимом, электростатическим прижимом или бесконтактный держатель с маской; с ВЧ–напряжением смещения
- Системы газового нагрева/охлаждения задней стороны подложкодержателя для точного поддержания температуры подложки
- Встроенное устройство для совмещения пластины и станция переворота пластины для металлизации обратной стороны пластины
- Высокая скорость дегазации, травления и осаждения металлов
- Буферная станция на объем до 12-ти пластин
- Роботизированная система SCARA с двухсторонними манипуляторами
- Источник распыления постоянного или импульсного постоянного тока ARQ310
- Модуль мягкого ИСП-травления позволяет обеспечить скорость удаления SiO2 (0,6÷0,8) нм/сек
- Охлаждение камеры ИСП реактора до -30°C с помощью Arctic Cooling Module
- Площадь размещения кластера: 4200 x 3700 мм
Evatec LLS EVO II (PVD)

- Универсальная кластерная платформа напыления на вертикально расположенные подложки металлов, токопроводящих оксидных слоев и магнитных пленок для серийного производства
- Назначение: осаждение многослойных магнитных слоев (например, NiFe, CoFeB, CoTaZr, ламинированных AlN, Al2O3, SiO2), осаждение металлов и сплавов (AuSn, AuZn, WTi, NiTi, TiN, Au, Al, Ag, Ti, Ni, Cu, Cr), осаждение Co с использованием до трех источников и т.п.
- Варианты загрузки: ручная или автоматическая из кассеты
- Ручная загрузка партий подложек одинаковых или разных размеров: ø2”– до 132шт, ø3” – до 72шт, ø4” – до 36шт, ø5” – до 30шт, ø6” – до 12шт и ø8” – до 9шт
- Максимальный размер подложек при групповой обработке: 200×230 мм
- Загрузочная камера с дегазацией. Возможность нагрева и очистки с помощью высокочастотного или ионно-лучевого травления.
- 6-осевой автоматизированный робот с кассетным буфером, с выравнивателем по плоскости и срезу и считывателем штрих-кода
- Количество процессных модулей: до 5-ти
- Температура подложки в рабочей камере: до 350°C
- Системы нагрева / охлаждения подложкодержателя для точного поддержания температуры подложки
- Вращающийся барабан-подложкодержатель
- Содержит до 5-ти вертикальных катодов, работающих в режимах постоянного тока, высокочастотного тока, совмещенного постоянного / высокочастотного тока или импульсного постоянного тока.
- Катоды с длительным сроком службы обеспечивают осаждение высокомагнитных материалов толщиной до 1 мм на пластинах ø8”
- Стандартное давление в технологической камере: 5,0 х 10-8 мбар
- Криокомпрессор CTI 9600
- Газовые линии с РРГ. Применяемые газы: Ar, O2, N2 и другие
- Высокоскоростная вакуумная система откачки: турбомолекулярные, криогенные и форвакуумные насосы
- Компьтерное управление на базе Windows 7 с системами отслеживания и регистрации информации о процессе, управления сигналами тревоги и с рецептами обработки
- Площадь размещения кластера: 3100 x 3400 мм
EvatecBAK501(PVD)

- Установка электронно-лучевого (термического) нанесения металлов и диэлектриков для НИОКР и мелкосерийного производства
- Назначение: осаждение слоев Al, Au, Ti, Pt, Cu, Ni, Cr, Mg, Mo, SiO2, Al2O3, MgF и пр. для полупроводникового производства, оптоэлектроники, оптики и микрооптики
- Загрузка: ручная, 47 пластин ø2″/ 20 пластин ø3″/ 9 пластин ø4″/ 5 пластин ø6″/ 3 пластины ø8″
- Система вращения держателей пластин
- Варианты держателей пластин: планетарная Кнудсена; флип-система для двустороннего покрытия; пользовательские системы
- Электронно-лучевая пушка EBS 500
- Термический источник
- Источник ионного напыления
- Количество ячеек для тиглей: 4÷10
- Нагрев лицевой и обратной стороны подложек
- Плазменная очистка тлеющим разрядом
- Наличие защитных экранов
- Система управления: компьютерная
- Контроль процесса: кварцевая измерительная головка QSK621; оптический мониторинг; анализатор остаточного газа
- Осушенный и очищенный сжатый воздух
- Вода: холодная и горячая
- Вакуумная система: турбомолекулярный / криогенный насос и форвакуумный насос
- Габариты: (1454x1980x1944) мм – длина с учетом открытой двери рабочей камеры
- Опции: устройства загрузки и держатель подложек под требования заказчика
Evatec BAK 641 (PVD)
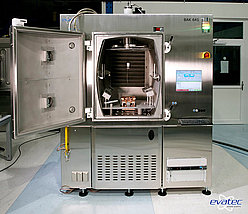
- Установка электронно-лучевого нанесения металлов и диэлектриков
- Назначение: осаждение слоев металлов и диэлектриков для полупроводникового производства, оптоэлектроники, прецизионной оптики, а также нанесение в реактивном, высокотемпературном процессе тонкопленочных слоев индиево-оловянного оксида для оптоэлектроники, солнечных элементов и LCD
- Подложки: кремниевые или стеклянные пластины
- Загрузка: 95 пластин ø2″/ 36 пластин ø3″/ 24 пластины ø4″/ 9 пластин ø6″/ 6 пластин ø8″
- Система вращения держателей пластин
- Варианты держателей пластин: стандартная – купольная; опционно — планетарная, флип-система, пользовательские
- До двух электронно-лучевых источников ESQ 212
- Источники резистивного нагрева
- Источник индуктивного нагрева для микроэлектроники
- Нагрев лицевой и обратной стороны подложек
- Канальный источник для сублимированных материалов
- Специальные источники для большого количества напыляемых материалов
- Количество ячеек для тиглей: 4
- Толщина пленок: (200÷260) нм
- Скорость роста: (0,1÷0,2) нм/сек
- Температура процесса:около 350°C
- Давление: 3х10-4 мбар
- Система управления: KHAN, компьютерная
- Вакуумная система: криогенный и форвакуумные насосы
- Габариты: (1800x3556x2100) мм – длина с учетом открытой двери рабочей камеры и вспомогательных блоков
- Опции: кварцевая или оптическая система мониторинга; температурный контроль оптическим пирометром
Evatec BAK 761 (PVD)
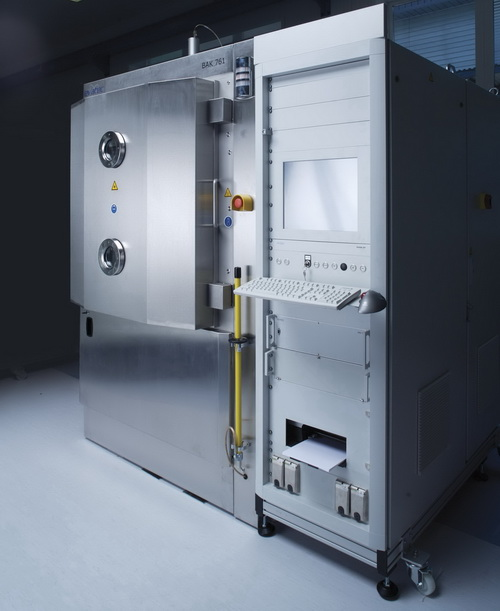
- Установка напыления для оптоэлектронного и полупроводникового серийного производства
- Назначение: осаждение слоев металлов и диэлектриков для фильтров поверхностно-аккустических волн, светодиодов, МЭМС, силовых приборов, оптики, фотоэлектрических приборов, датчиков
- Загрузка: ручная или кассетная, 152 пластины ø2″/ 64 пластины ø3″/ 40 пластин ø4″/ 18 пластин ø6″/ 9 пластин ø8″
- Система вращения держателей пластин
- Варианты держателей пластин: стандартная – купольная; опционно – планетарная, флип-система, пользовательские
- Варианты конструкции рабочей камеры: Standart Throw – для типового осаждения металлов и диэлектриков; Extended Throw – для “lift off”; Split Chamber – для реактивных материалов; Extended rear – для осаждения и травления по требованиям заказчика
- До трех электронно-лучевых источников EBS 500
- Термические источники
- Ионные и плазменные источники для травления и осаждения
- Нагрев лицевой и обратной стороны подложек
- Специальный источник и системы подачи для толстых слоев
- Полный спектр устройств загрузки и держателей подложек под требования заказчика
- Система управления: KHAN, компьютерная
- Вакуумная система: криогенный и форвакуумные насосы
- Габариты: (3300(1900)x3300(2100)x2100) мм – максимальная длина с учетом открытой двери рабочей камеры, максимальная шириина с учетом вспомогательных блоков и открытой двери блока управления
- Опции: кварцевая или оптическая система мониторинга; температурный контроль оптическим пирометром
Evatec BAK 901 (PVD)

- Среднеразмерная установка физического осаждения и травления для оптоэлектронного и полупроводникового серийного производства
- Назначение: осаждение слоев металлов и диэлектриков для фильтров поверхностно-аккустических волн, светодиодов, МЭМС, силовых приборов, оптики, фотоэлектрических приборов, датчиков
- Загрузка: ручная или кассетная, 186 пластин ø2″/ 88 пластин ø3″/ 51 пластина ø4″/ 23 пластины ø6″/ 10 пластин ø8″
- Система вращения держателей пластин
- Варианты держателей пластин: стандартная – купольная; опционно – планетарная, флип-система, пользовательские
- Варианты конструкции рабочей камеры: Standart Throw – для типового осаждения металлов и диэлектриков; Extended Throw – для “lift off”; Split Chamber – для реактивных материалов; Extended rear – для осаждения и травления по требованиям заказчика
- До трех электронно-лучевых источников
- Термические источники
- Ионные и плазменные источники для травления и осаждения
- Нагрев лицевой и обратной стороны подложек
- Специальный источник и системы подачи для толстых слоев
- Система управления: KHAN, компьютерная
- Вакуумная система: турбомолекулярный / криогенный и форвакуумные насосы
- Габариты: (2700(2100)x2900x2700) мм – длина с учетом вспомогательных блоков, максимальная шириина с учетом вспомогательных блоков
- Опции: кварцевая или оптическая система мониторинга; температурный контроль оптическим пирометром
Evatec BAK 1101 (PVD)

- Установка физического осаждения и травления для рентабельного круглосуточного, крупносерийного оптоэлектронного и полупроводникового производства, прецизионной оптики
- Назначение: осаждение слоев металлов и диэлектриков для фильтров поверхностно-аккустических волн, светодиодов, МЭМС, силовых приборов, оптики, фотоэлектрических приборов, датчиков
- Загрузка: ручная или кассетная, 216 пластин ø2″/ 104 пластины ø3″/ 64 пластины ø4″/ 24 пластины ø6″/ 16 пластин ø8″
- Система вращения держателей пластин
- Варианты держателей пластин: стандартная – купольная; опционно – планетарная, флип-система, пользовательские
- Варианты конструкции рабочей камеры: Standart Throw – для типового осаждения металлов и диэлектриков; Extended Throw – для “lift off”; Split Chamber – для реактивных материалов; Extended rear – для осаждения и травления по требованиям заказчика
- До трех электронно-лучевых источников EBS 500
- Термические источники
- Цилиндрические источники и эффузионные ячейки
- Ионные и плазменные источники для травления и осаждения
- Нагрев лицевой и обратной стороны подложек
- Линейные и круглые катоды для напыления
- Система управления: KHAN, компьютерная
- Вакуумная система: турбомолекулярный / криогенный и форвакуумные насосы
- Габариты: (3321(2261)x4448x2035) мм – максимальная шириина с учетом вспомогательных блоков и открытой двери блока управления, максимальная длина с учетом открытой двери рабочей камеры и вспомогательных блоков, высота приведена без учета высоты механизма вращения и системы контроля
- Опции: кварцевая или оптическая система мониторинга; температурный контроль оптическим пирометром
Показать меньшеEvatec BAV 1250 (PVD)

Высокопроизводительная установка физического осаждения и травления для технологической обработки больших поверхностей, подложек со сложной геометрией или нанесения покрытий на большие партии изделий в области электроники и прецизионной оптики
Evatec BAK 1401 (PVD)

- Установка физического осаждения и травления для крупносерийного оптоэлектронного и полупроводникового производства, прецизионной оптики
- Загрузка: ручная или кассетная, 330 пластин ø2″/ 167 пластин ø3″/ 104 пластины ø4″/ 47 пластин ø6″/ 28 пластин ø8″
- Система вращения держателей пластин
- Варианты держателей пластин: стандартная – купольная; опционно – планетарная, флип-система, пользовательские
- Варианты конструкции рабочей камеры: Standart Throw – для типового осаждения металлов и диэлектриков; Extended Throw – для “lift off”; Split Chamber – для реактивных материалов; Extended rear – для осаждения и травления по требованиям заказчика
- 6 ячеек для электронно-лучевых источников EBS
- Термические источники
- Цилиндрические источники и эффузионные ячейки
- Ионные и плазменные источники для травления и осаждения
- Нагрев лицевой и обратной стороны подложек
- Линейные и круглые катоды для напыления
- Система управления: KHAN, компьютерная
- Высокопроизводительная вакуумная система: турбомолекулярный / криогенный и форвакуумные насосы
- Опции: кварцевая или оптическая система мониторинга; температурный контроль оптическим пирометром
Evatec BAV 2000 (PVD)

- Установка физического осаждения и травления для рентабельного круглосуточного, массового оптоэлектронного и полупроводникового производства, прецизионной оптики
- Загрузка: ручная или кассетная, пластины ø2″ и ø3″ – по запросу/ 256 пластин ø4″/ 114 пластин ø6″/ 65 пластин ø8″
- Система вращения держателей пластин
- Варианты держателей пластин: стандартная – купольная; опционно — планетарная, флип-система, пользовательские
- Варианты конструкции рабочей камеры: Standart Throw – для типового осаждения металлов и диэлектриков; Extended Throw – для “lift off”; Split Chamber – для реактивных материалов; Extended rear – для осаждения и травления по требованиям заказчика
- Комплект из нескольких электронно-лучевых источников EBS
- Термические источники
- Цилиндрические источники и эффузионные ячейки
- Ионные и плазменные источники для травления и осаждения
- Нагрев лицевой и обратной стороны подложек
- Линейные и круглые катоды для напыления
- Система управления: KHAN, компьютерная
- Высокопроизводительная вакуумная система: турбомолекулярный / криогенный и форвакуумные насосы
- Габариты: (2900x5900x2000) мм – максимальная шириина с учетом вспомогательных блоков, максимальная длина с учетом открытой двери рабочей камеры и вспомогательных блоков, высота приведена без учета высоты механизма вращения и системы контроля
- Опции: кварцевая или оптическая система мониторинга; температурный контроль оптическим пирометром
Evatec MSP 1225/1232 (PVD)

- Высокопроизводительная узкоспециализированная установка магнетронного напыления для массового производства в области высокоточной оптики и оптоэлектроники
- Назначение: для производства высококачественных металлических, диэлектрических и оптических слоев, включая полосовые фильтры, просветляющие покрытия на стекле и полимерных подложках, формирования изображений узкополосных режекторных фильтров, прозрачных проводящих оксидов и прочего
- Варианты исполнения (модели) установки: MSP 1225 и MSP 1232
- Загрузка: MSP 1225 — 96 пластин ø4″/ 44 пластин ø6″/ 16 пластин ø8″/ 12 пластин ø10″/ 10 пластин ø12″/ 60 подложек 180 х 110 мм/ 48 подложек 180 х 136 мм/ 24 подложек 270 х 136 мм; MSP 1232 — 160 пластин ø4″/ 66 пластин ø6″/ 32 пластин ø8″/ 24 пластин ø10″/ 10 пластин ø12″/ 90 подложек 180 х 110 мм/ 72 подложек 180 х 136 мм/ 48 подложек 270 х 136 мм; максимальный размер подложки — 560×380 мм
- Площадь напыления: MSP 1225 – 1,5 м2; MSP 1232 – 2,2 м2
- Система вращения держателей пластин
- До 6 катодов для напыления постоянным током / сдвоенными магнетронами
- Встроенный источник плазмы для выполнения предварительной очистки и возможности получения новых вариантов нанесения покрытия
- Низкая температура процессов для подложек из чувствительных материалов
- Система управления: KHAN, компьютерная
- Высокопроизводительная сдвоенная вакуумная система с турбомолекулярными и форвакуумные насосами для одновременной откачки сверху и снизу рабочей камеры
- Габариты: (3800x5900x2600) мм – максимальная длина с учетом открытых дверей рабочей камеры и вспомогательных блоков
- Опции: оптическая система контроля
EvatecSAMSON (PVD)

- Двухкамерная установка напыления для серийного производства
- Назначение: осаждение высокореактивных материалов или сложных сплавов (где важен стехиометрический состав)
- Подложки: пластины ø6”, ø8”
- Камера подложек вентилируется во время загрузки / разгрузки
- Камера с источником сохраняется непрерывно под вакуумом
- Электронно-лучевые источники EBS 500
- Высокотемпературные эффузионные источники с устойчивым регулированием температуры до 2000°C
- Продувка камеры с подложками предельно сокращает производственный цикл — для высокопроизводительных процессов на 6-или 8-дюймовых пластинах
Презентации
Инженерное оборудование
Технологическое оборудование
- Carbolite Gero GmbH
- CRYSTAL Systems
- FCT SYSTEME
- Nabertherm
- SALE
- АО «Монокристалл»
- Гиредмет
- Главная
- ЗАВОД «КРИСТАЛЛ»
- Имплантация
- Лицензии
- О компании
- Оборудование
- Измерения
- Испытания
- ACUTRONIC
- AC105-AVAB
- AC1120S
- AC1125
- AC1180-AB
- AC1190-140
- AC150-AVAB
- AC216, AC217
- AC2246, AC2247, AC2267
- AC2255-RS
- AC2277
- AC2295-VA
- AC3337
- AC3347-140
- AC3347-210
- AC3347-TC
- AC3350-08, AC3350-140
- AC3350-140
- AC3351, AC3351-140
- AC3357, AC3360, AC3351, AC3351-140
- AC3360
- AC3367, AC3367-70, AC3367-TC
- AC3380, AC3380-TC
- AC8800
- GA3397
- HD33H-T45.60, HD33H-S50.77, HD33H-S55.77
- HD55H-S35.70, HD55H-T35-50, HD55H-S50.100, HD55H-T65.60, AC55H-S20.40
- simex®ONE
- АС8827
- Центрифуги
- CVMS Climatic
- CVMS Climatic камеры дождя — испытательные камеры
- CVMS Climatic камеры испытательные тепла-холода-влажности объемом от 100 до 1000 л.
- CVMS Climatic камеры озона — испытательные камеры
- CVMS Climatic настольные климатические камеры
- Камеры песка и пыли CVMS Climatic
- Камеры пониженного давления CVMS Climatic
- Камеры солнечного излучения CVMS Climatic
- Камеры соляного тумана CVMS Climatic
- Климатические камеры термоудара CVMS Climatic
- Sentek Dynamics
- Вибростенды E серии (экстрасильные 200 — 400 кН) с водяным охлаждением
- Вибростенды H серии (высокосильные 65 — 160 кН) с водяным охлаждением
- Вибростенды L серии (малосильные 1 — 10 кН) с воздушным охлаждением
- Вибростенды M серии (средне сильные 15- 65 кН) с воздушным охлаждением
- Вибростенды длинного хода T серии (30 — 54 кН) с воздушным охлаждением
- Высокопроизводительные вибростенды P серии с водяным охлаждением
- Модальные вибростенды MS серии
- Настольные вибростенды VT серии
- Трехосевые вибростенды MA серии с воздушным охлаждением
- Thermotron Industries
- Автоматизированные камеры для коррозионных испытаний ACT
- Камеры для испытаний на воздействие песка и пыли
- Камеры дождя
- Камеры имитации солнечного излучения
- Климатические камеры серии SE
- Климатические камеры экономичных серий S и SM
- Комбинированные климатические камеры серии AGREE
- Настольные климатические камеры серии S/SM
- Панельные и сварные климатические камеры серии WP
- Система тестирования сопротивления защитной изоляции PTS
- Системы непрерывного мониторинга PTS
- Термошоковые климатические камеры серии ATSS
- Электродинамические стенды Thermotron
- TIRA GmbH
- Вибрационные стенды TIRA с выталкивающим усилием от 1 кН до 2,7 кН
- Вибрационные стенды TIRA с выталкивающим усилием от 20 кН до 55 кН
- Вибрационные стенды TIRA с выталкивающим усилием от 4 кН до 15 кН
- Вибрационные стенды TIRA с выталкивающим усилием от 60 кН до 300 кН
- Вибрационные стенды TIRA с выталкивающим усилием т 9 Н до 400 Н
- ACUTRONIC
- Литография
- 4PICO Litho B.V.
- CRESTEC
- ELS System Technology Co., Ltd.
- ELS 106FA
- ELS 106FA-B
- ELS 106SA
- ELS 108FA
- ELS 108SA
- ELS 112SA
- ELS 3604FA, ELS 3606FA
- ELS 3608FA
- ELS 3612FA
- ELS 407FA
- ELS 450FA
- ELS 504FA, ELS 506FA, ELS 508FA
- ELS 504FA, ELS 506FA, ELS 508FA
- ELS 512FA
- ELS 604FA
- ELS 606FA
- ELS 706SA
- ELS 708SA
- ELS 712SA
- ELS 7604FA, ELS 7606FA
- ELS 7608FA
- ELS 7612FA
- ELS 807FA
- ELS 904FA, ELS 906FA
- ELS 908FA
- Heidelberg Instruments Mikrotechnik
- JEOL-LITO
- KLOE
- RAITH
- Ultratech Stepper Inc.
- VISTEC Electron Beam GmbH
- ОАО «КБТЭМ-ОМО»
- Плазмохимия
- Advanced Vacuum System
- APPLIED Materials
- Applied Materials AMAT Centris AdvantEdge Mesa Etch (FE-ICP)
- Applied Materials AMAT Centura (5200 / Ultima Plus) HDP CVD 200mm
- Applied Materials AMAT Centura (AP) Ultima X HDP-CVD
- Applied Materials AMAT Centura 5200 (II) Etch 200mm (ICP/RIE/DCP/MW)
- Applied Materials AMAT Centura AdvantEdge Mesa / G5 Etch (FE-ICP)
- Applied Materials AMAT Producer (Producer S) PECVD 200mm
- Applied Materials AMAT Producer Etch eXT (ICP)
- Applied Materials AMAT Producer GT (Avila TSV) PECVD
- Applied Materials AMAT Producer SE (APF) PECVD 300mm
- CORIAL
- Diener electronic GmbH+Co.KG
- Evatec AG
- FHR Anlagenbau
- FHR ALD 100
- FHR ALD 150
- FHR ALD 300
- FHR ALD 300
- FHR FLA 100
- FHR FLA 100-DL
- FHR FLA 200-A
- FHR MS120-FLA
- FHR-Star300BOX
- FHR.Boxx.400-PVD
- FHR.Flash.50-Module
- FHR.Micro.100-RIE
- FHR.Micro.150-DuoPVD
- FHR.Micro.150-MonoEVA
- FHR.Micro.150-PECVD
- FHR.Micro.160-FLA
- FHR.Micro.160-IBE-RIE
- FHR.Micro.200-ALD
- FHR.Micro.200-PVD
- FHR.Micro.300-Clean
- FHR.Star.300 (PVD)
- GNtech
- LAM Research
- Lam Research LAM 2300 Exelan FLEX / FLEX 45 (RIE/TCP)
- Lam Research LAM 2300 Syndion TSV (RIE/TCP)
- Lam Research LAM 2300 Versys Kiyo (RIE/TCP/MW)
- Lam Research LAM 2300 Versys Kiyo 45 (RIE/TCP/MW)
- Lam Research LAM 2300 Versys Metal (RIE/TCP/MW)
- Lam Research LAM 2300 Versys Poly / Star T (RIE/TCP/MW)
- Lam Research LAM Alliance A4 TCP 9400 DFM (ICP/CCP/MW)
- Lam Research LAM Alliance A6 9400 PTX (RIE/TCP)
- Lam Research LAM Alliance A6 9600 DFM (RIE/TCP/MW)
- Lam Research LAM Alliance A6 9600 PTX (RIE/TCP/MW)
- Lam Research LAM Alliance A6 Exelan HPT (RIE/TCP)
- Lam Research LAM Alliance A6 TCP 9400 DFM (RIE/TCP)
- Lam Research LAM TCP 9400 SE(RIE/TCP)
- Lam Research LAM VECTOR Express / Extreme (PECVD)
- MTI Corporation
- Nordson MARCH
- Oxford Instruments
- Nanofab 700 (800 Agile)
- PlasmaPro 100
- PlasmaPro 100 Cobra
- PlasmaPro 100 Estrelas
- PlasmaPro 100 ICPCVD
- PlasmaPro 100 PECVD
- PlasmaPro 100 Polaris
- PlasmaPro 100 RIE
- PlasmaPro 1000 Astrea
- PlasmaPro 1000 Stratum
- PlasmaPro 80 Cobra65 ICP
- PlasmaPro 80 ICPCVD
- PlasmaPro 80 PECVD
- PlasmaPro 80 RIE
- PlasmaPro 800 plus
- PlasmaPro NGP 80
- Plasma Etch
- PLASMA-THERM
- SAMCO
- SAMCO PC-1100(RIE/PE)
- SAMCO PC-300(RIE/PE)
- SAMCO PC-5000(PE)
- SAMCO PD-100ST (PECVD)
- SAMCO PD-2203L (PECVD)
- SAMCO PD-220LC (PECVD)
- SAMCO PD-220N, NA (PECVD)
- SAMCO PD-220NL (PECVD)
- SAMCO PD-270STL(PECVD)
- SAMCO PD-270STP (PECVD)
- SAMCO PD-330STLC(PECVD)
- SAMCO PD-3800 (PECVD)
- SAMCO PD-3800L (PECVD)
- SAMCO PD-4800 (PECVD)
- SAMCO PD-5400 (PECVD)
- SAMCO RIE-100iPC (ICP)
- SAMCO RIE-101iPH (ICP)
- SAMCO RIE-10iP (ICP)
- SAMCO RIE-10NR
- SAMCO RIE-1C
- SAMCO RIE-200C
- SAMCO RIE-200iP (ICP)
- SAMCO RIE-200LC
- SAMCO RIE-200NL
- SAMCO RIE-212IP (ICP)
- SAMCO RIE-230iPC (ICP)
- SAMCO RIE-300NR
- SAMCO RIE-330iPC (ICP)
- SAMCO RIE-400iP (ICP)
- SAMCO RIE-400iPB (ICP)
- SAMCO RIE-600iP (ICP)
- SAMCO RIE-600iPC (ICP)
- SAMCO RIE-800iPB (ICP)
- SAMCO RIE-800iPBC(ICP)
- SENTECH Instruments
- sidmel
- Tokyo Electron
- Trion Technology
- Trion Technology Apollo (ICP/MW/RIE)
- Trion Technology Gemini (ICP/MW/SST)
- Trion Technology Minilock-Orion III (PECVD)
- Trion Technology Minilock-Phantom III (RIE/RIE+ICP)
- Trion Technology Oracle III (RIE/RIE+ICP/PECVD)
- Trion Technology Orion III (PECVD)
- Trion Technology Phantom III (RIE/RIE+ICP)
- Trion Technology Sirus T2 Table Top (RIE)
- Trion Technology Titan (RIE/RIE+HDICP/PECVD)
- Trymax Semiconductor
- ULVAC Technologies
- Yield Engineering Systems
- АО «НИИТМ»
- ООО НПК «ТехМашСервис»
- СтратНаноТек Инвест
- Рост слитков
- ACCRETECH /TOKYO SEIMITSU CO/
- Carbolite Gero GmbH
- Centorr Vacuum Industries,Inc
- Engis Corporation
- ENGIS AMX Fine Grinder, ENGIS AMX Lapper, ENGIS AMX Polisher
- ENGIS Double Sided Grinding Machines
- ENGIS EHG180, ENGIS EHG250
- ENGIS Hyprez Composite Lapping Plates
- ENGIS Hyprez Diamond and Non-Diamond Lapping Slurries
- ENGIS Hyprez Diamond Compounds and Diamond Paste
- ENGIS Hyprez Electrogrip Diamond Plated & Dia-ForZ Products
- ENGIS Hyprez Family of Lapping Lubricants
- ENGIS Hyprez Micron and CBN Diamond Powders
- ENGIS Hyprez MiniMiser & Autostirrer
- ENGIS Hyprez Planarization & Polishing Pads
- FERROTEC
- Lapmaster Wolters GmbH
- LAPMASTER WOLTERS 3R-600, LAPMASTER WOLTERS 4R-1200 (single wheel machine)
- LAPMASTER WOLTERS AC 1500-P3, LAPMASTER WOLTERS AC 2000-P2
- LAPMASTER WOLTERS AC microLine 1000
- LAPMASTER WOLTERS AC microLine 1200
- LAPMASTER WOLTERS AC microLine 1500
- LAPMASTER WOLTERS AC microLine 2000
- LAPMASTER WOLTERS AC microLine 400
- LAPMASTER WOLTERS AC microLine 535
- LAPMASTER WOLTERS AC microLine 700
- LAPMASTER WOLTERS BD 300-L
- LAPMASTER WOLTERS DDG 450, LAPMASTER WOLTERS DDG 450 Closeup
- LAPMASTER WOLTERS DDG 600, LAPMASTER WOLTERS DDG 600 Closeup
- LAPMASTER WOLTERS MACRO
- LAPMASTER WOLTERS MACRO-I
- LAPMASTER WOLTERS MACRO-L
- LAPMASTER WOLTERS MACRO-S, LAPMASTER WOLTERS MACRO-SI
- LAPMASTER WOLTERS MACRO-SK
- Linton Crystal Technologies
- Meyer Burger Wafertec
- PVA TEPLA
- ООО «НПО «ГКМП»
- Термопроцессы
- AnnealSys
- ATV Technologie
- Centrotherm thermal solutions
- Centrotherm Activator 150-5 (50)
- Centrotherm CAV 150, Centrotherm CAV 200.
- Centrotherm CLV 200
- Centrotherm CMV 200, Centrotherm 300.
- Centrotherm E 1200
- Centrotherm E 1550
- Centrotherm E 2000
- Centrotherm Epicoo 200
- Centrotherm Oxidator 150-5,Centrotherm Oxidator 150-50
- Centrotherm RTP 150
- Centrotherm Single Tube
- FHR Anlagenbau
- gkmp32
- JIPELEC
- Kokusai Electric
- Kokusai Electric Advanced Ace-300
- Kokusai Electric DD-803V
- Kokusai Electric Lambda 300/300N
- Kokusai Electric Lambda Strip 3000 / 3000 II
- Kokusai Electric MARORA
- Kokusai Electric MG 8500R/8500ZS 200mm
- Kokusai Electric QUIXACE (QUIXACE-L/L) DD-1206V-DF 300 mm
- Kokusai Electric QUIXACE DJ-1206VN-DF (Aldinna)
- Kokusai Electric QUIXACE II ALD High-k 300 mm (ALD)
- Kokusai Electric Quixace II DD-1206V-DF NITRIDE 300 mm
- Kokusai Electric Quixace II DJ-1206VN-DF Doped Poly 300 mm
- Kokusai Electric TANDUO
- Kokusai Electric TSURUGI-C²
- Kokusai Electric Vertron III
- Kokusai Electric Vertron III DJ-803V
- Kokusai Electric VERTRON Revolution 200 mm
- Kokusai ElectricVertron DJ-803V
- Kokusai ElectricVertron III DD-803V
- SEMCO
- SVCS Process Innovation
- TEL
- TEMPRESS
- Thermco Systems
- TORR INTERNATIONAL SERVICES LLC
- Tystar
- АО «НИИТМ»
- АО «НТО» (SemiTEq®)
- ООО НПК «ТехМашСервис»
- Физические процессы
- Applied Materials
- ASM International
- EVATEC
- FHR Anlagenbau
- FHR ALD 100 (ALD)
- FHR ALD 150 (PEALD)
- FHR ALD 300 (ALD)
- FHR ALD 300 НИОКР (ALD)
- FHR-Star300BOX (PVD)
- FHR.Boxx.400-PVD (PVD)
- FHR.Micro.150-DuoPVD (PVD)
- FHR.Micro.150-MonoEVA (PVD)
- FHR.Micro.160-IBE-RIE (IBE)
- FHR.Micro.200-ALD
- FHR.Micro.200-PVD (PVD)
- FHR.Star.100-TetraCo (PVD)
- FHR.Star.150-Co (PVD)
- FHR.Star.220 (PVD)
- FHR.Star.300 (PVD/ALD)
- IZOVAC
- Kokusai Electric
- KOREA VAC-TEC CO. LTD
- KOREA VAC-TEC ERIDAN (PVD)
- KOREA VAC-TEC In-Line Low Temperature Sputter System (PVD)
- KOREA VAC-TEC In-Line TCO Sputter System (PVD)
- KOREA VAC-TEC ORION-140T (PVD)
- KOREA VAC-TEC ORION-400 (PVD)
- KOREA VAC-TEC ORION-40T (PVD)
- KOREA VAC-TEC ORION-90T (PVD)
- KOREA VAC-TEC ORION-BE (PVD)
- KOREA VAC-TEC VTC 1000 TO (PVD)
- KOREA VAC-TEC VTC 1100 PO (PVD)
- KOREA VAC-TEC VTC-1200-СP (PVD)
- KOREA VAC-TEC VTC-1350DP (PVD)
- KOREA VAC-TEC VTC-IBE-200-RF (IBE)
- Lam Research
- MTI Corporation
- Oxford Instruments
- Plasma-Therm
- SAMCO
- SENTECH Instruments
- Tokyo Electron
- TORR
- Trion Technology
- ULVAC Technologies
- ULVAC CS-200 (PVD)
- ULVAC CS-L 150мм / 200мм (PVD)
- ULVAC Ei-5 (EB/RH)
- ULVAC ENTRON-EX W-200S / W-200T6 200мм (PVD)
- ULVAC ENTRON-EX W-300 300мм (PVD/ALD/CVD)
- ULVAC ENTRON-EX2 W-300 300мм
- ULVAC MLX-3000N cluster (PVD)
- ULVAC SME-200 cluster (PVD)
- ULVAC SME-200E cluster (PVD)
- ULVAC SME-200J cluster (PVD)
- ULVAC SRH-420/420МС cluster (PVD)
- ULVAC SRH-530 cluster (PVD)
- ULVAC SRH-820 cluster (PVD)
- АО «Кварц»
- АО «НИИТМ»
- АО «НТО» (SemiTEq®)
- ООО «ИОНТЕК-нано»
- ООО «РУ-ВЭМ»
- ООО «СтратНаноТек Инвест»
- Химобработка
- AP&S
- Acetoncarussel
- Chemical Distribution System
- Chemical Waste System
- CMS, Slurry System
- GigaStep
- LOTUS systems — Линия жидкостной химической обработки
- LOTUS systems — Установка жидкостной химической обработки
- LOTUS systems 1
- LOTUS systems 2
- MIXTURA Small
- MultiStep
- NID Dryer
- PURUS DUPLEX
- PURUS MAXIM
- PURUS SIMPLEX
- SIMPLEX & DUPLEX
- TwinStep
- VulCanio
- Wet processor manual
- Вытяжной шкаф
- Очистка лодочек
- Очистка труб
- Установка для очистки сточных вод
- Установка ЖХО
- Установка очистки
- Установка очистки
- Установка РХО
- Установка сушки пластин
- EV Group
- INERT Technology
- Ramgraber
- Автоматическая система очистки поликристаллических кусков кремния CHUNK STAR
- Автоматическая система электролиза PLATING STAR
- Автоматическая система электрохимической металлизации PLATING STAR
- Модель DEGLUE STAR
- Модель TIGER
- Оборудование для IPA сушки
- Полуавтоматическая система EMMA
- Ручная система электролиза PLATER
- Ручная система электрохимической металлизации PLATER
- Система жидкостной химической обработки с установкой ополаскивания и сушки
- Система конвейерной очистки пластин кремния INLINE STAR
- Система ополаскивания и сушки SRD
- Система очистки кварцевых труб QUARTZ TUBE CLEANER
- Система с ручным управлением
- Установка для обработки отдельной пластины SPIN ETCH
- Установка для спрей-обработки в кислоте RAMOS SAT
- Установка для спрей-обработки в растворителе RAMOS SST
- SCREEN Semiconductor Solutions Co.(DAINIPPON SCREEN)
- Singulus Stangl Solar
- STALIS
- STROZA
- STROZA — Установка для подготовки и распределения NH4OH + DIW
- STROZA — Установка для травления полупроводниковых пластин
- STROZA — Установка отмывки кремниевых пластин
- STROZA — Установка отмывки кремниевых пластин в процессе травления
- STROZA — Установка отмывки кремниевых пластин после полировки
- STROZA — Установка смешения и распределения химиката TMAH
- STROZA — Установка травления кремниевых пластин (нержавеющая сталь)
- STROZA — Установка травления кремниевых труб
- STROZA — Химический вытяжной шкаф для промывки деталей
- STROZA — Химический шкаф для мойки канистр и тары
- STROZA — Химический шкаф для травления и отмывки кремниевых пластин
- STROZA — Химический шкаф для травления пластин
- STROZA — Шкаф для струйного травления краев кремниевых пластин
- STROZA — Шкаф подачи неорганических химикатов
- STROZA — Шкаф подачи органических химикатов
- STROZA — Шкаф распределения подачи химикатов
- STROZA — Шкаф хранения перчаток для чистых помещений
- STROZA – Химический шкаф для работы с кислотами
- THERMCO SYSTEM
- T-Clean
- TERMCO SYSTEMS — Установка для травления кремниевых труб
- TERMCO SYSTEMS — Установки формирования пористого кремния
- TERMCO SYSTEMS — Установки химического осаждения металлов
- TERMCO SYSTEMS — Шкафы закачки для хранения, смешения, подачи химикатов
- TERMCO SYSTEMS – Химические шкафы для подачи химикатов
- TSE-SYSTEME GmbH
- Вытяжные химические шкафы
- Камера травления
- Очиститель кварцевых труб и кварцевых деталей (вертикальный/горизонтальный) VTC / HTC
- Система распределения подачи химикатов CDS
- Система сбора отработанных химикатов WCCS
- Системы распределения химикатов POU-Box
- Системы смешивания химикатов
- Универсальная установка очистки и отмывки с фильтрацией воздуха и вытяжкой Digestorium
- Установка отмывки пластин методом распыления WSC
- Установки жидкостной химической обработки с автоматическим управлением AWB
- Установки жидкостной химической обработки с полуавтоматическим управлением SWB
- Установки жидкостной химической обработки с ручным управлением MWB
- Установки отмывки кассет, боксов CBC 200 и Foup+Fosb FFC 300
- АО «НИИТОП»
- АО «НИИПМ»
- ООО «АтомСтрой»
- ООО «Корпорация спецтехнологического оборудования «ВИТРИ»
- AP&S
- Эпитаксия
- AIXTRON
- ASM International
- CDS Epitaxy
- LPE
- RIBER
- SCIENTA OMICRON
- SCIENTA OMICRON Charge & spin transport in graphene layers on 2 inch substrates
- SCIENTA OMICRON EVO-25 MBE
- SCIENTA OMICRON EVO-50 MBE
- SCIENTA OMICRON Hybrid (PLD) Laser-MBE System
- SCIENTA OMICRON III-N MBE system for 3 inch substrates with additional in situ VT SPM
- SCIENTA OMICRON III-V MBE system for film growth on 4 inch wafers
- SCIENTA OMICRON Lab10 MBE
- SCIENTA OMICRON MBE & Catalysis
- SCIENTA OMICRON PRO-100 MBE
- SCIENTA OMICRON PRO-75 MBE
- SCIENTA OMICRON UHV PLD and MULTIPROBE Compact
- SCIENTA OMICRON UHV SPM / XPS / UPS / MBE
- TNSC
- VEECO
- Veeco Discovery 180 (D180) LDM MOCVD
- Veeco Discovery 180 (D180) MOCVD
- Veeco E300 GaNzilla II MOCVD
- Veeco E300 LDM MOCVD
- Veeco E450 GaNzilla MOCVD
- Veeco GEN II MBE
- Veeco GEN III MBE
- Veeco GEN10 MBE
- Veeco GEN20 MBE
- Veeco GEN200 Edge MBE
- Veeco GEN2000 Edge MBE
- Veeco GEN930 MBE
- Veeco GENxplor MBE
- Veeco Pioneer P125 MOCVD
- Veeco Propel Power MOCVD
- Veeco TurboDisc E450 LDM MOCVD
- Veeco TurboDisc E450 MOCVD
- Veeco TurboDisc E475 MOCVD
- Veeco TurboDisc EPIK 700 MOCVD
- Veeco TurboDisc K300 MOCVD
- Veeco TurboDisc K465 MOCVD
- Veeco TurboDisc K465i HP MOCVD
- Veeco TurboDisc K465i MOCVD
- Veeco TurboDisc K475 MOCVD
- Veeco TurboDisc K475i MOCVD
- Veeco TurboDisc MaxBright M MOCVD
- Veeco TurboDisc MaxBright MHP MOCVD
- Мехобработка
- Оборудование
- Партнеры
- Планаризация
- Проектирование промышленных объектов
- Проектирование чистых помещений
- Реализованные объекты. Научные исследования
- Реализованные объекты. Радиоэлектронное приборостроение
- Реализованные объекты. Фотовольтаика, энергетика, материаловедение
- Реализованные объекты. Электронная промышленность
- Рост слитков
- Термобарокамеры (камеры пониженного давления)
- Термострессовые виброкамеры AST
- Термошоковые климатические камеры серии ATS
- Услуги
- ФГУП ЭЗАН
- Эпитаксия
- Контакты
