АО «НИИТМ»
ПЛАЗМА ТМ 300
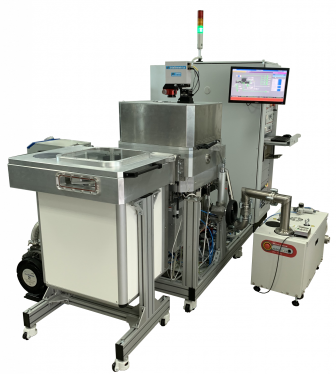
- Установка плазмохимического травления для мелкосерийного производства
- Назначение: для группового плазмохимического травления диэлектрических (SiO₂, Si₃N₄ и другие), металлических (Al, Cr и другие), полупроводниковых и полимерных слоев на пластинах
- Подложки: пластины до ø300мм
- Шлюзовая камера для загрузки – выгрузки подложек из кассеты в кассету
- Тип загрузки пластин: FOUP контейнер
- Система переноса носителя подложек из шлюзовой камеры в реактор на основе манипулятора
- Температура нагрева стенок реактора: до 60°С
- Гелиевое охлаждение и механический прижим пластин
- Рабочие газы: Cl₂, HBr, SF₆, CF₄, CHF₃, O₂, Ar, He и пр.
- Вакуумная система: турбомолекулярный и безмасляный форвакуумный насосы
- Микропроцессорная система управления
- Возможность встраивания в чистую комнату
- Электроэнергия: 380/220В, 3ф, 50гц, ≤21 кВт
ПЛАЗМА ТМ 200-01
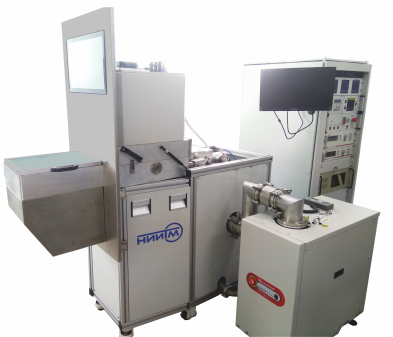
- Установка плазмохимического травления для мелкосерийного производства
- Назначение: для плазмохимического травления поликристаллического кремния и нитрида кремния (мелкощелевая изоляция в кремнии)
- Подложки: пластины ø76мм, ø100мм, ø150мм, ø200мм
- Шлюзовая камера для загрузки – выгрузки подложек или пластин
- Варианты загрузки пластин: SMIF контейнер, из кассеты в кассету, шлюзовая
- Система переноса пластин на основе манипулятора
- Камера рабочая алюминиевая, цельнометаллическая с моторизованным подъемом колпака и нагревом стенок
- Температура нагрева стенок реактора: до 60°С
- Гелиевое охлаждение и механический прижим подложки или пластины
- Источник напряжения смещения на подложку
- Рабочие газы: Cl2, HBr, SF6, CF4, O2, N2, He и пр.
- Сжатый воздух: (0,4÷0,6)Мпа, 30л/мин, 12 класс загрязненности по ГОСТ 17433-80
- N2 технический: 99,5%, (2,5÷6)атм, (28÷44)л/мин
- Скорость анизотропного травления кремния: ≥(0,5÷1) мкм/мин
- Неравномерность травления для бинарного рельефа: ≤5%
- Порт для оптического контроля плазмы по спектру
- Вакуумная система: турбомолекулярный и безмасляный форвакуумный насосы
- Микропроцессорная система управления
- Чиллер охлаждения установки HRS050-AF-B (SMC)
- Охлаждающая вода (предусмотрено охлаждение на базе автономного источника – чиллера): ≥10л/мин, (17÷22)°С
- Возможность встраивания в чистую комнату
- Возможность быть в составе кластера
- Электроэнергия: 380/220В, 3ф, 50гц, ≤19 кВт
- Занимаемая площадь: ~6м2
ПЛАЗМА ТМ 200-02

- Установка плазмохимического травления для мелкосерийного производства
- Назначение: для индивидуального или группового глубокого плазмохимического анизотропного ICP травления кремния в производстве МЭМС, НЭМС, сборок 2,5D и 3D, а также сквозных высокоаспектных отверстий и др. на базе Bosch-процесса
- Режимы работы: ручной, автоматический
- Подложки: 60х48мм; пластины ø76мм, ø100мм, ø150мм, ø200мм
- Шлюзовая камера для загрузки – выгрузки подложек или пластин
- Объем загрузки: 60х48мм – 7 шт.; ø76мм – 4 шт.; ø100мм, ø150мм, ø200мм – 1 шт.
- Система переноса носителя из шлюзовой камеры в реактор на основе манипулятора
- Камера рабочая алюминиевая, цельнометаллическая с моторизованным подъемом колпака и нагревом стенок
- Температура нагрева стенок реактора: до 60°С
- Гелиевое охлаждение и механический прижим пластин
- ВЧ источник плазмы: ≥3000Вт, 13,56МГц
- Газовая система: 5 газовых каналов (опционно – до 8)
- Рабочие газы: He, SF6, C4F8, O2, Ar и пр.
- Скорость анизотропного травления кремния: ≥(0,5÷1) мкм/мин
- Вакуумная система: турбомолекулярный и безмасляный форвакуумный насосы, отдельный форвакуумный насос для шлюзовой камеры
- Микропроцессорная система управления
- Система водяного охлаждения на базе чиллера
- Возможность встраивания в чистую комнату
- Возможность быть в составе кластера
- Электроэнергия: 380/220В, 3ф, 50гц, ≤19 кВт
- Габаритные размеры со шкафом управления: ≤1600х3200х1800мм
- Вес: ≤1400кг
ПЛАЗМА ТМ 200-03
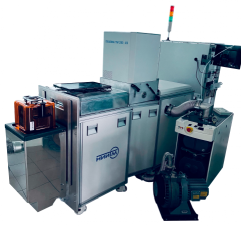
- Установка плазмохимического травления для мелкосерийного производства
- Назначение: для высокоселективных процессов плазмохимического удаления фоторезистивной маски и травления органических полимеров
- Подложки: пластины ø76мм, ø100мм, ø150мм, ø200мм
- Шлюзовая камера для загрузки – выгрузки подложек или пластин
- Варианты загрузки пластин: SMIF контейнер, из кассеты в кассету, шлюзовая
- Система переноса носителя из шлюзовой камеры в реактор на основе манипулятора
- Температура нагрева рабочий стола: до 250°С
- Удаленный источник СВЧ плазмы для травления радикалами
- Рабочие газы: He, SF6, C4F8, O2, Ar и пр.
- Вакуумная система: турбомолекулярный и безмасляный форвакуумный насосы
- Микропроцессорная система управления
- Система водяного охлаждения
- Возможность встраивания в чистую комнату
- Возможность быть в составе кластера
- Электроэнергия: 380/220В, 3ф, 50гц, ≤15,5кВт
ПЛАЗМА ТМ 200-04
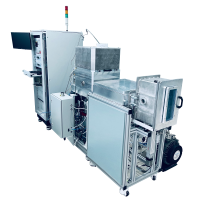
- Установка атомно-слоевого травления с ICP плазмой для мелкосерийного производства
- Назначение: для атомно-слоевого травления оксида кремния, кремния и очистки поверхности
- Подложки: пластины ø76мм, ø100мм, ø150мм, ø200мм
- Шлюзовая камера для загрузки – выгрузки подложек
- Камера рабочая алюминиевая
- Система прогрева стенок реактора: встроенными нагревателями
- Температура нагрева стенок реактора: до 60°С
- Варианты исполнения системы загрузки: шлюзовая, из кассеты в кассету, SMIF контейнер
- Транспортная система переноса подложек из шлюзовой камеры в рабочую камеру на основе манипулятора
- Стол для травления с подачей гелия под пластину, с механическим устройством прижима и подачей ВЧ-напряжения смещения
- Температура рабочего стола: (-30÷+100)°C
- Источник ICP плазмы с цилиндрическим индуктором для формирования высокоплотной плазмы
- Рабочие газы: He, SF6, C4F8, O2, Ar и пр.
- Скорость травления SiO2, Si: (0,1÷1)нм/цикл
- Вакуумная система: турбомолекулярный и безмасляный форвакуумный насосы
- Микропроцессорная система управления
- Возможность встраивания в чистую комнату
- Может входить в кластерный комплекс
- Система водяного охлаждения
- Электроэнергия: 380/220В, 3ф, 50гц
ПЛАЗМА ТМ 7

- Установка плазмохимического травления для НИОКР и мелкосерийного производства
- Назначение: для индивидуального травления диэлектрических слоев и полупроводниковых материалов методом реактивно-ионного травления
- Подложки: пластины ø76мм, ø100мм, ø150мм
- Загрузка: из кассеты в кассету
- Шлюзовая камера для загрузки – выгрузки подложек или пластин из кассеты в кассету
- Система переноса пластин из шлюзовой камеры в реактор на основе манипулятора
- Регулирование и автоматическое поддержание мощности ВЧ рабочего стола: (50÷400)Вт
- Газовая система: 4 газовых канала с РРГ
- Рабочие газы: He, SF6, C3F8, O2, Ar, CF4, CHF3 и пр.
- Сжатый воздух
- Микропроцессорная система управления
- Возможность встраивания в чистую комнату
- Вакуумная система: безмасляный форвакуумный насос
- Электроэнергия: 380/220В, 3ф, 50гц, ≤6,5кВт
ПЛАЗМА ТМ 8

- Установка плазмохимического травления для НИОКР и мелкосерийного производства
- Назначение: для индивидуального реактивно-ионного травления алюминиевой металлизации в хлорсодержащей плазме, а также тонких металлических слоев (Au, Pt, Ti, и др.), диэлектрических слоев (SiO2, SiN и др.), кремниевых слоев (Si, a-Si, поли-Si), материалов группы А3B5 (GaAs, InP, GaN, и др.)
- Подложки: пластины ø76мм, ø100мм, ø150мм
- Загрузка: из кассеты в кассету
- Шлюзовая камера для загрузки – выгрузки подложек или пластин из кассеты в кассету
- Система переноса пластин из шлюзовой камеры в реактор на основе манипулятора
- Внутренний диаметр камеры: 300мм
- Температура нагрева стенок реактора: (50÷70)°С
- Регулирование и автоматическое поддержание мощности ВЧ рабочего стола: (50÷400)Вт
- Измерение напряжения на ВЧ рабочем столе: (0÷1000)В
- Газовая система: 4 газовых канала с РРГ
- Рабочие газы: Cl, BCl3, He и пр.
- Сжатый воздух
- Скорость травления Al: (3000÷5000)Å/мин
- Микропроцессорная система управления
- Возможность встраивания в чистую комнату
- Вакуумная система: безмасляный форвакуумный насос
- Электроэнергия: 380/220В, 3ф, 50гц, ≤12 кВт
ПЛАЗМА ТМ 09

- Установка плазмохимического травления для НИОКР и мелкосерийного производства
- Назначение: для индивидуального и группового плазмохимического селективного (реактивно-ионного, анизотропного) травления кварца, пирекса, алмазных пленок, карбида кремния и других труднотравимых диэлектрических и полупроводниковых слоев
- Подложки: 60х48мм; пластины ø76мм, ø100мм, ø150мм
- Загрузка: ручная
- Объем загрузки: 60х48мм – 3шт; пластины ø76мм, ø100мм, ø150мм – по 1 шт.
- Регулирование и автоматическое поддержание мощности ВЧ рабочего стола: (400÷600)Вт
- Измерение напряжения на ВЧ рабочем столе: (0÷1000)В
- Гелиевое охлаждение пластин
- Рабочие газы: SF6, C4F8, O2, CHF3 и пр.
- Скорость травления: (0,5÷1,5)мкм/мин
- Микропроцессорная система управления
- Возможность встраивания в чистую комнату
- Вакуумная система: безмасляный форвакуумный насос
- Электроэнергия: 380/220В, 3ф, 50гц, ≤7 кВт
МВУ ТМ ПЛАЗМА 03
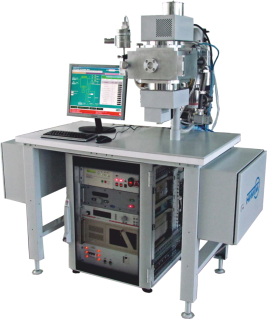
- Установка плазмохимического травления для НИОКР и мелкосерийного производства
- Назначение: для индивидуального плазмохимического селективного (реактивно-ионного, анизотропного) травления диэлектрических и металлических слоев
- Подложки: пластины ø76мм, ø100мм, ø150мм
- Загрузка: ручная
- Объем загрузки: пластины ø76мм, ø100мм, ø150мм – по 1 шт.
- ВЧ источник IСР: 13,56 МГц, до 1000 Вт
- ВЧ генератор стола-подложкодержателя: 13,56 МГц, до 600 Вт
- Регулирование и автоматическое поддержание мощности ВЧ рабочего стола: (30÷200)Вт
- Регулирование и автоматическое поддержание уровня мощности ICP источника плазмы: (400÷600)Вт
- Измерение напряжения на ВЧ рабочем столе: (0÷1000)В
- Гелиевое охлаждение пластин
- Газовая система: 4 газовых каналов с РРГ
- Рабочие газы: SF6, CF4, O2, Ar и пр.
- Скорость изотропного травления (1÷3)мкм/мин
- Скорость анизотропного травления кремния: (0,5÷1,0)мкм/мин
- Неравномерность травления кремния на пластине ø100мм: ±3%
- Микропроцессорная система управления
- Вакуумная система: турбомолекулярный (ТМН 300) и безмасляный форвакуумный насосы
- Электроэнергия: 380/220В, 3ф, 50гц, ≤6,5 кВт
- Занимаемая площадь: ~2,5м2
ПЛАЗМА ТМ 4
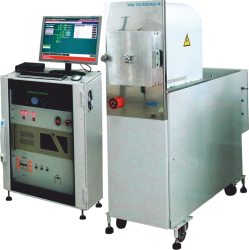
- Установка плазмохимического травления для НИОКР и мелкосерийного производства
- Назначение: для группового плазмохимического удаления фоторезиста и очистки органических примесей на пластинах, а также стерилизации медицинских, в том числе термолабильных инструментов, приспособлений, ёмкостей, посуды и т.д.
- Загрузка: ручная
- Подложки: пластины ø76мм, ø100мм, ø150мм
- Объем загрузки: до 20 пластин в кварцевой лодочке
- Поддержание стабильного ВЧ разряда при (10÷100)Па
- Рабочие газы: N2, O2 и пр.
- Микропроцессорная система управления
- Вакуумная система: безмасляный форвакуумный насос
- Электроэнергия: 380/220В, 3ф, 50гц, ≤4,5 кВт
ИЗОФАЗ ТМ 300

- Установка плазмохимического осаждения для серийного производства
- Назначение: для группового низкотемпературного плазмохимического осаждения диэлектрических слоев оксида или нитрида кремния из газовой фазы
- Подложки: пластины до ø300мм
- Шлюзовая камера для загрузки – выгрузки подложек из кассеты в кассету
- Тип загрузки пластин: FOUP контейнер
- Система переноса носителя подложек из шлюзовой камеры в реактор на основе манипулятора
- Температура нагрева стенок реактора: до 60°С
- Нагрев рабочего стола: до 350°С
- Для создания смещения на подложку подается ВЧ мощность на нагреваемый рабочий столик реактора
- Источник ICP: 13,56 МГц
- Рабочие газы: SiH₄, O₂, N₂, N₂O, He, Ar и пр.
- Скорость осаждения слоев SiO₂: ≥0,5нм/с
- Вакуумная система: турбомолекулярный и безмасляный форвакуумный насосы
- Микропроцессорная система управления
- Возможность встраивания в чистую комнату
- Электроэнергия: 380/220В, 3ф, 50гц, ≤21 кВт
ИЗОФАЗ ТМ 200-01
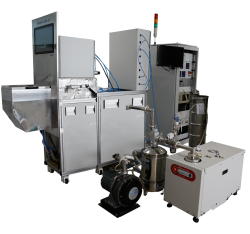
- Установка атомно-слоевого осаждения с ICP плазмой для мелкосерийного производства
- Назначение: для атомно-слоевого осаждения свертонких пленок (в т.ч. Al2O3)
- Подложки: пластины ø76мм, ø100мм, ø150мм, ø200мм
- Шлюзовая камера для загрузки – выгрузки подложек или пластин
- Варианты загрузки пластин: SMIF контейнер, из кассеты в кассету, шлюзовая
- Система переноса пластин на основе манипулятора
- Осаждение в термическом режиме с удаленным ICP источником плазмы
- ВЧ-генератор: 13,56МГц
- Порты для подключения ампул с прекурсором с высоким давлением насыщенных паров: 2шт
- Порты для подключения ампул с низким давлением насыщенных паров: 2шт (опционально до 4 шт.)
- Температура нагрева рабочего стола: до 300°С
- Рабочие газы: O2, N2, He и пр.
- При термическом АСО прекурсоры: ТМА (Al(CH3)3, подогреваемый до 30°С) и деионизованная вода (H20, охлаждаемая до 18°С)
- При плазменном АСО прекурсоры:
- Вакуумная система: турбомолекулярный и безмасляные форвакуумные насосы
- Микропроцессорная система управления
- Возможность встраивания в чистую комнату
- Может входить в кластерный комплекс
- Электроэнергия: 380/220В, 3ф, 50гц, ≤14 кВт
ИЗОФАЗ ТМ 200-02
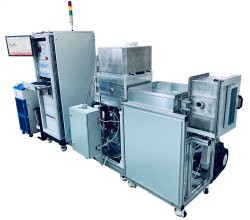
- Установка плазмохимического осаждения для мелкосерийного производства
- Назначение: для плазмохимического осаждения диэлектрических слоев с ICP источником плазмы для формирования щелевой и межслойной изоляции, в том числе на стенках контактных и переходных отверстий межслойных соединений
- Подложки: пластины ø76мм, ø100мм, ø150мм, ø200мм
- Шлюзовая камера для загрузки – выгрузки подложек или пластин
- Варианты загрузки пластин: SMIF контейнер, из кассеты в кассету, шлюзовая
- Система переноса пластин на основе манипулятора
- Температура нагрева подложкодержателя: (200÷300)°С
- Микропроцессорная система управления
- Возможность встраивания в чистую комнату
- Может входить в кластерный комплекс
- Электроэнергия: 380/220В, 3ф, 50гц, ≤18кВт
Презентации
Показать
Инженерное оборудование
Показать
Технологическое оборудование
Показать
- Carbolite Gero GmbH
- CRYSTAL Systems
- FCT SYSTEME
- Nabertherm
- SALE
- АО «Монокристалл»
- Гиредмет
- Главная
- ЗАВОД «КРИСТАЛЛ»
- Имплантация
- Лицензии
- О компании
- Оборудование
- Измерения
- Испытания
- ACUTRONIC
- AC105-AVAB
- AC1120S
- AC1125
- AC1180-AB
- AC1190-140
- AC150-AVAB
- AC216, AC217
- AC2246, AC2247, AC2267
- AC2255-RS
- AC2277
- AC2295-VA
- AC3337
- AC3347-140
- AC3347-210
- AC3347-TC
- AC3350-08, AC3350-140
- AC3350-140
- AC3351, AC3351-140
- AC3357, AC3360, AC3351, AC3351-140
- AC3360
- AC3367, AC3367-70, AC3367-TC
- AC3380, AC3380-TC
- AC8800
- GA3397
- HD33H-T45.60, HD33H-S50.77, HD33H-S55.77
- HD55H-S35.70, HD55H-T35-50, HD55H-S50.100, HD55H-T65.60, AC55H-S20.40
- simex®ONE
- АС8827
- Центрифуги
- CVMS Climatic
- CVMS Climatic камеры дождя — испытательные камеры
- CVMS Climatic камеры испытательные тепла-холода-влажности объемом от 100 до 1000 л.
- CVMS Climatic камеры озона — испытательные камеры
- CVMS Climatic настольные климатические камеры
- Камеры песка и пыли CVMS Climatic
- Камеры пониженного давления CVMS Climatic
- Камеры солнечного излучения CVMS Climatic
- Камеры соляного тумана CVMS Climatic
- Климатические камеры термоудара CVMS Climatic
- Sentek Dynamics
- Вибростенды E серии (экстрасильные 200 — 400 кН) с водяным охлаждением
- Вибростенды H серии (высокосильные 65 — 160 кН) с водяным охлаждением
- Вибростенды L серии (малосильные 1 — 10 кН) с воздушным охлаждением
- Вибростенды M серии (средне сильные 15- 65 кН) с воздушным охлаждением
- Вибростенды длинного хода T серии (30 — 54 кН) с воздушным охлаждением
- Высокопроизводительные вибростенды P серии с водяным охлаждением
- Модальные вибростенды MS серии
- Настольные вибростенды VT серии
- Трехосевые вибростенды MA серии с воздушным охлаждением
- Thermotron Industries
- Автоматизированные камеры для коррозионных испытаний ACT
- Камеры для испытаний на воздействие песка и пыли
- Камеры дождя
- Камеры имитации солнечного излучения
- Климатические камеры серии SE
- Климатические камеры экономичных серий S и SM
- Комбинированные климатические камеры серии AGREE
- Настольные климатические камеры серии S/SM
- Панельные и сварные климатические камеры серии WP
- Система тестирования сопротивления защитной изоляции PTS
- Системы непрерывного мониторинга PTS
- Термошоковые климатические камеры серии ATSS
- Электродинамические стенды Thermotron
- TIRA GmbH
- Вибрационные стенды TIRA с выталкивающим усилием от 1 кН до 2,7 кН
- Вибрационные стенды TIRA с выталкивающим усилием от 20 кН до 55 кН
- Вибрационные стенды TIRA с выталкивающим усилием от 4 кН до 15 кН
- Вибрационные стенды TIRA с выталкивающим усилием от 60 кН до 300 кН
- Вибрационные стенды TIRA с выталкивающим усилием т 9 Н до 400 Н
- ACUTRONIC
- Литография
- 4PICO Litho B.V.
- CRESTEC
- ELS System Technology Co., Ltd.
- ELS 106FA
- ELS 106FA-B
- ELS 106SA
- ELS 108FA
- ELS 108SA
- ELS 112SA
- ELS 3604FA, ELS 3606FA
- ELS 3608FA
- ELS 3612FA
- ELS 407FA
- ELS 450FA
- ELS 504FA, ELS 506FA, ELS 508FA
- ELS 504FA, ELS 506FA, ELS 508FA
- ELS 512FA
- ELS 604FA
- ELS 606FA
- ELS 706SA
- ELS 708SA
- ELS 712SA
- ELS 7604FA, ELS 7606FA
- ELS 7608FA
- ELS 7612FA
- ELS 807FA
- ELS 904FA, ELS 906FA
- ELS 908FA
- Heidelberg Instruments Mikrotechnik
- JEOL-LITO
- KLOE
- RAITH
- SMEE
- Ultratech Stepper Inc.
- VISTEC Electron Beam GmbH
- ОАО «КБТЭМ-ОМО»
- Плазмохимия
- Advanced Vacuum System
- APPLIED Materials
- Applied Materials AMAT Centris AdvantEdge Mesa Etch (FE-ICP)
- Applied Materials AMAT Centura (5200 / Ultima Plus) HDP CVD 200mm
- Applied Materials AMAT Centura (AP) Ultima X HDP-CVD
- Applied Materials AMAT Centura 5200 (II) Etch 200mm (ICP/RIE/DCP/MW)
- Applied Materials AMAT Centura AdvantEdge Mesa / G5 Etch (FE-ICP)
- Applied Materials AMAT Producer (Producer S) PECVD 200mm
- Applied Materials AMAT Producer Etch eXT (ICP)
- Applied Materials AMAT Producer GT (Avila TSV) PECVD
- Applied Materials AMAT Producer SE (APF) PECVD 300mm
- CORIAL
- Diener electronic GmbH+Co.KG
- Evatec AG
- FHR Anlagenbau
- FHR ALD 100
- FHR ALD 150
- FHR ALD 300
- FHR ALD 300
- FHR FLA 100
- FHR FLA 100-DL
- FHR FLA 200-A
- FHR MS120-FLA
- FHR-Star300BOX
- FHR.Boxx.400-PVD
- FHR.Flash.50-Module
- FHR.Micro.100-RIE
- FHR.Micro.150-DuoPVD
- FHR.Micro.150-MonoEVA
- FHR.Micro.150-PECVD
- FHR.Micro.160-FLA
- FHR.Micro.160-IBE-RIE
- FHR.Micro.200-ALD
- FHR.Micro.200-PVD
- FHR.Micro.300-Clean
- FHR.Star.300 (PVD)
- GNtech
- LAM Research
- Lam Research LAM 2300 Exelan FLEX / FLEX 45 (RIE/TCP)
- Lam Research LAM 2300 Syndion TSV (RIE/TCP)
- Lam Research LAM 2300 Versys Kiyo (RIE/TCP/MW)
- Lam Research LAM 2300 Versys Kiyo 45 (RIE/TCP/MW)
- Lam Research LAM 2300 Versys Metal (RIE/TCP/MW)
- Lam Research LAM 2300 Versys Poly / Star T (RIE/TCP/MW)
- Lam Research LAM Alliance A4 TCP 9400 DFM (ICP/CCP/MW)
- Lam Research LAM Alliance A6 9400 PTX (RIE/TCP)
- Lam Research LAM Alliance A6 9600 DFM (RIE/TCP/MW)
- Lam Research LAM Alliance A6 9600 PTX (RIE/TCP/MW)
- Lam Research LAM Alliance A6 Exelan HPT (RIE/TCP)
- Lam Research LAM Alliance A6 TCP 9400 DFM (RIE/TCP)
- Lam Research LAM TCP 9400 SE(RIE/TCP)
- Lam Research LAM VECTOR Express / Extreme (PECVD)
- MTI Corporation
- Nordson MARCH
- Oxford Instruments
- Nanofab 700 (800 Agile)
- PlasmaPro 100
- PlasmaPro 100 Cobra
- PlasmaPro 100 Estrelas
- PlasmaPro 100 ICPCVD
- PlasmaPro 100 PECVD
- PlasmaPro 100 Polaris
- PlasmaPro 100 RIE
- PlasmaPro 1000 Astrea
- PlasmaPro 1000 Stratum
- PlasmaPro 80 Cobra65 ICP
- PlasmaPro 80 ICPCVD
- PlasmaPro 80 PECVD
- PlasmaPro 80 RIE
- PlasmaPro 800 plus
- PlasmaPro NGP 80
- Plasma Etch
- PLASMA-THERM
- SAMCO
- SAMCO PC-1100(RIE/PE)
- SAMCO PC-300(RIE/PE)
- SAMCO PC-5000(PE)
- SAMCO PD-100ST (PECVD)
- SAMCO PD-2203L (PECVD)
- SAMCO PD-220LC (PECVD)
- SAMCO PD-220N, NA (PECVD)
- SAMCO PD-220NL (PECVD)
- SAMCO PD-270STL(PECVD)
- SAMCO PD-270STP (PECVD)
- SAMCO PD-330STLC(PECVD)
- SAMCO PD-3800 (PECVD)
- SAMCO PD-3800L (PECVD)
- SAMCO PD-4800 (PECVD)
- SAMCO PD-5400 (PECVD)
- SAMCO RIE-100iPC (ICP)
- SAMCO RIE-101iPH (ICP)
- SAMCO RIE-10iP (ICP)
- SAMCO RIE-10NR
- SAMCO RIE-1C
- SAMCO RIE-200C
- SAMCO RIE-200iP (ICP)
- SAMCO RIE-200LC
- SAMCO RIE-200NL
- SAMCO RIE-212IP (ICP)
- SAMCO RIE-230iPC (ICP)
- SAMCO RIE-300NR
- SAMCO RIE-330iPC (ICP)
- SAMCO RIE-400iP (ICP)
- SAMCO RIE-400iPB (ICP)
- SAMCO RIE-600iP (ICP)
- SAMCO RIE-600iPC (ICP)
- SAMCO RIE-800iPB (ICP)
- SAMCO RIE-800iPBC(ICP)
- SENTECH Instruments
- sidmel
- Tokyo Electron
- Trion Technology
- Trion Technology Apollo (ICP/MW/RIE)
- Trion Technology Gemini (ICP/MW/SST)
- Trion Technology Minilock-Orion III (PECVD)
- Trion Technology Minilock-Phantom III (RIE/RIE+ICP)
- Trion Technology Oracle III (RIE/RIE+ICP/PECVD)
- Trion Technology Orion III (PECVD)
- Trion Technology Phantom III (RIE/RIE+ICP)
- Trion Technology Sirus T2 Table Top (RIE)
- Trion Technology Titan (RIE/RIE+HDICP/PECVD)
- Trymax Semiconductor
- ULVAC Technologies
- Yield Engineering Systems
- АО «НИИТМ»
- ООО НПК «ТехМашСервис»
- СтратНаноТек Инвест
- Рост слитков
- ACCRETECH /TOKYO SEIMITSU CO/
- Carbolite Gero GmbH
- Centorr Vacuum Industries,Inc
- Engis Corporation
- ENGIS AMX Fine Grinder, ENGIS AMX Lapper, ENGIS AMX Polisher
- ENGIS Double Sided Grinding Machines
- ENGIS EHG180, ENGIS EHG250
- ENGIS Hyprez Composite Lapping Plates
- ENGIS Hyprez Diamond and Non-Diamond Lapping Slurries
- ENGIS Hyprez Diamond Compounds and Diamond Paste
- ENGIS Hyprez Electrogrip Diamond Plated & Dia-ForZ Products
- ENGIS Hyprez Family of Lapping Lubricants
- ENGIS Hyprez Micron and CBN Diamond Powders
- ENGIS Hyprez MiniMiser & Autostirrer
- ENGIS Hyprez Planarization & Polishing Pads
- FERROTEC
- Lapmaster Wolters GmbH
- LAPMASTER WOLTERS 3R-600, LAPMASTER WOLTERS 4R-1200 (single wheel machine)
- LAPMASTER WOLTERS AC 1500-P3, LAPMASTER WOLTERS AC 2000-P2
- LAPMASTER WOLTERS AC microLine 1000
- LAPMASTER WOLTERS AC microLine 1200
- LAPMASTER WOLTERS AC microLine 1500
- LAPMASTER WOLTERS AC microLine 2000
- LAPMASTER WOLTERS AC microLine 400
- LAPMASTER WOLTERS AC microLine 535
- LAPMASTER WOLTERS AC microLine 700
- LAPMASTER WOLTERS BD 300-L
- LAPMASTER WOLTERS DDG 450, LAPMASTER WOLTERS DDG 450 Closeup
- LAPMASTER WOLTERS DDG 600, LAPMASTER WOLTERS DDG 600 Closeup
- LAPMASTER WOLTERS MACRO
- LAPMASTER WOLTERS MACRO-I
- LAPMASTER WOLTERS MACRO-L
- LAPMASTER WOLTERS MACRO-S, LAPMASTER WOLTERS MACRO-SI
- LAPMASTER WOLTERS MACRO-SK
- Linton Crystal Technologies
- Meyer Burger Wafertec
- PVA TEPLA
- ООО «НПО «ГКМП»
- Термопроцессы
- AnnealSys
- ATV Technologie
- Centrotherm thermal solutions
- Centrotherm Activator 150-5 (50)
- Centrotherm CAV 150, Centrotherm CAV 200.
- Centrotherm CLV 200
- Centrotherm CMV 200, Centrotherm 300.
- Centrotherm E 1200
- Centrotherm E 1550
- Centrotherm E 2000
- Centrotherm Epicoo 200
- Centrotherm Oxidator 150-5,Centrotherm Oxidator 150-50
- Centrotherm RTP 150
- Centrotherm Single Tube
- FHR Anlagenbau
- gkmp32
- JIPELEC
- Kokusai Electric
- Kokusai Electric Advanced Ace-300
- Kokusai Electric DD-803V
- Kokusai Electric Lambda 300/300N
- Kokusai Electric Lambda Strip 3000 / 3000 II
- Kokusai Electric MARORA
- Kokusai Electric MG 8500R/8500ZS 200mm
- Kokusai Electric QUIXACE (QUIXACE-L/L) DD-1206V-DF 300 mm
- Kokusai Electric QUIXACE DJ-1206VN-DF (Aldinna)
- Kokusai Electric QUIXACE II ALD High-k 300 mm (ALD)
- Kokusai Electric Quixace II DD-1206V-DF NITRIDE 300 mm
- Kokusai Electric Quixace II DJ-1206VN-DF Doped Poly 300 mm
- Kokusai Electric TANDUO
- Kokusai Electric TSURUGI-C²
- Kokusai Electric Vertron III
- Kokusai Electric Vertron III DJ-803V
- Kokusai Electric VERTRON Revolution 200 mm
- Kokusai ElectricVertron DJ-803V
- Kokusai ElectricVertron III DD-803V
- SEMCO
- SVCS Process Innovation
- TEL
- TEMPRESS
- Thermco Systems
- TORR INTERNATIONAL SERVICES LLC
- Tystar
- АО «НИИТМ»
- АО «НТО» (SemiTEq®)
- ООО НПК «ТехМашСервис»
- Физические процессы
- Applied Materials
- ASM International
- EVATEC
- FHR Anlagenbau
- FHR ALD 100 (ALD)
- FHR ALD 150 (PEALD)
- FHR ALD 300 (ALD)
- FHR ALD 300 НИОКР (ALD)
- FHR-Star300BOX (PVD)
- FHR.Boxx.400-PVD (PVD)
- FHR.Micro.150-DuoPVD (PVD)
- FHR.Micro.150-MonoEVA (PVD)
- FHR.Micro.160-IBE-RIE (IBE)
- FHR.Micro.200-ALD
- FHR.Micro.200-PVD (PVD)
- FHR.Star.100-TetraCo (PVD)
- FHR.Star.150-Co (PVD)
- FHR.Star.220 (PVD)
- FHR.Star.300 (PVD/ALD)
- IZOVAC
- Kokusai Electric
- KOREA VAC-TEC CO. LTD
- KOREA VAC-TEC ERIDAN (PVD)
- KOREA VAC-TEC In-Line Low Temperature Sputter System (PVD)
- KOREA VAC-TEC In-Line TCO Sputter System (PVD)
- KOREA VAC-TEC ORION-140T (PVD)
- KOREA VAC-TEC ORION-400 (PVD)
- KOREA VAC-TEC ORION-40T (PVD)
- KOREA VAC-TEC ORION-90T (PVD)
- KOREA VAC-TEC ORION-BE (PVD)
- KOREA VAC-TEC VTC 1000 TO (PVD)
- KOREA VAC-TEC VTC 1100 PO (PVD)
- KOREA VAC-TEC VTC-1200-СP (PVD)
- KOREA VAC-TEC VTC-1350DP (PVD)
- KOREA VAC-TEC VTC-IBE-200-RF (IBE)
- Lam Research
- MTI Corporation
- Oxford Instruments
- Plasma-Therm
- SAMCO
- SENTECH Instruments
- Tokyo Electron
- TORR
- Trion Technology
- ULVAC Technologies
- ULVAC CS-200 (PVD)
- ULVAC CS-L 150мм / 200мм (PVD)
- ULVAC Ei-5 (EB/RH)
- ULVAC ENTRON-EX W-200S / W-200T6 200мм (PVD)
- ULVAC ENTRON-EX W-300 300мм (PVD/ALD/CVD)
- ULVAC ENTRON-EX2 W-300 300мм
- ULVAC MLX-3000N cluster (PVD)
- ULVAC SME-200 cluster (PVD)
- ULVAC SME-200E cluster (PVD)
- ULVAC SME-200J cluster (PVD)
- ULVAC SRH-420/420МС cluster (PVD)
- ULVAC SRH-530 cluster (PVD)
- ULVAC SRH-820 cluster (PVD)
- АО «Кварц»
- АО «НИИТМ»
- АО «НТО» (SemiTEq®)
- ООО «ИОНТЕК-нано»
- ООО «РУ-ВЭМ»
- ООО «СтратНаноТек Инвест»
- Химобработка
- AP&S
- Acetoncarussel
- Chemical Distribution System
- Chemical Waste System
- CMS, Slurry System
- GigaStep
- LOTUS systems — Линия жидкостной химической обработки
- LOTUS systems — Установка жидкостной химической обработки
- LOTUS systems 1
- LOTUS systems 2
- MIXTURA Small
- MultiStep
- NID Dryer
- PURUS DUPLEX
- PURUS MAXIM
- PURUS SIMPLEX
- SIMPLEX & DUPLEX
- TwinStep
- VulCanio
- Wet processor manual
- Вытяжной шкаф
- Очистка лодочек
- Очистка труб
- Установка для очистки сточных вод
- Установка ЖХО
- Установка очистки
- Установка очистки
- Установка РХО
- Установка сушки пластин
- EV Group
- INERT Technology
- Ramgraber
- Автоматическая система очистки поликристаллических кусков кремния CHUNK STAR
- Автоматическая система электролиза PLATING STAR
- Автоматическая система электрохимической металлизации PLATING STAR
- Модель DEGLUE STAR
- Модель TIGER
- Оборудование для IPA сушки
- Полуавтоматическая система EMMA
- Ручная система электролиза PLATER
- Ручная система электрохимической металлизации PLATER
- Система жидкостной химической обработки с установкой ополаскивания и сушки
- Система конвейерной очистки пластин кремния INLINE STAR
- Система ополаскивания и сушки SRD
- Система очистки кварцевых труб QUARTZ TUBE CLEANER
- Система с ручным управлением
- Установка для обработки отдельной пластины SPIN ETCH
- Установка для спрей-обработки в кислоте RAMOS SAT
- Установка для спрей-обработки в растворителе RAMOS SST
- SCREEN Semiconductor Solutions Co.(DAINIPPON SCREEN)
- Singulus Stangl Solar
- STALIS
- STROZA
- STROZA — Установка для подготовки и распределения NH4OH + DIW
- STROZA — Установка для травления полупроводниковых пластин
- STROZA — Установка отмывки кремниевых пластин
- STROZA — Установка отмывки кремниевых пластин в процессе травления
- STROZA — Установка отмывки кремниевых пластин после полировки
- STROZA — Установка смешения и распределения химиката TMAH
- STROZA — Установка травления кремниевых пластин (нержавеющая сталь)
- STROZA — Установка травления кремниевых труб
- STROZA — Химический вытяжной шкаф для промывки деталей
- STROZA — Химический шкаф для мойки канистр и тары
- STROZA — Химический шкаф для травления и отмывки кремниевых пластин
- STROZA — Химический шкаф для травления пластин
- STROZA — Шкаф для струйного травления краев кремниевых пластин
- STROZA — Шкаф подачи неорганических химикатов
- STROZA — Шкаф подачи органических химикатов
- STROZA — Шкаф распределения подачи химикатов
- STROZA — Шкаф хранения перчаток для чистых помещений
- STROZA – Химический шкаф для работы с кислотами
- THERMCO SYSTEM
- T-Clean
- TERMCO SYSTEMS — Установка для травления кремниевых труб
- TERMCO SYSTEMS — Установки формирования пористого кремния
- TERMCO SYSTEMS — Установки химического осаждения металлов
- TERMCO SYSTEMS — Шкафы закачки для хранения, смешения, подачи химикатов
- TERMCO SYSTEMS – Химические шкафы для подачи химикатов
- TSE-SYSTEME GmbH
- Вытяжные химические шкафы
- Камера травления
- Очиститель кварцевых труб и кварцевых деталей (вертикальный/горизонтальный) VTC / HTC
- Система распределения подачи химикатов CDS
- Система сбора отработанных химикатов WCCS
- Системы распределения химикатов POU-Box
- Системы смешивания химикатов
- Универсальная установка очистки и отмывки с фильтрацией воздуха и вытяжкой Digestorium
- Установка отмывки пластин методом распыления WSC
- Установки жидкостной химической обработки с автоматическим управлением AWB
- Установки жидкостной химической обработки с полуавтоматическим управлением SWB
- Установки жидкостной химической обработки с ручным управлением MWB
- Установки отмывки кассет, боксов CBC 200 и Foup+Fosb FFC 300
- АО «НИИТОП»
- АО «НИИПМ»
- ООО «АтомСтрой»
- ООО «Корпорация спецтехнологического оборудования «ВИТРИ»
- AP&S
- Эпитаксия
- Advanced Micro-Fabrication Equipment Inc. China
- AIXTRON
- ASM International
- CDS Epitaxy
- LPE
- NAURA
- RIBER
- SCIENTA OMICRON
- SCIENTA OMICRON Charge & spin transport in graphene layers on 2 inch substrates
- SCIENTA OMICRON EVO-25 MBE
- SCIENTA OMICRON EVO-50 MBE
- SCIENTA OMICRON Hybrid (PLD) Laser-MBE System
- SCIENTA OMICRON III-N MBE system for 3 inch substrates with additional in situ VT SPM
- SCIENTA OMICRON III-V MBE system for film growth on 4 inch wafers
- SCIENTA OMICRON Lab10 MBE
- SCIENTA OMICRON MBE & Catalysis
- SCIENTA OMICRON PRO-100 MBE
- SCIENTA OMICRON PRO-75 MBE
- SCIENTA OMICRON UHV PLD and MULTIPROBE Compact
- SCIENTA OMICRON UHV SPM / XPS / UPS / MBE
- Shenzhen
- TNSC
- VEECO
- Veeco Discovery 180 (D180) LDM MOCVD
- Veeco Discovery 180 (D180) MOCVD
- Veeco E300 GaNzilla II MOCVD
- Veeco E300 LDM MOCVD
- Veeco E450 GaNzilla MOCVD
- Veeco GEN II MBE
- Veeco GEN III MBE
- Veeco GEN10 MBE
- Veeco GEN20 MBE
- Veeco GEN200 Edge MBE
- Veeco GEN2000 Edge MBE
- Veeco GEN930 MBE
- Veeco GENxplor MBE
- Veeco Pioneer P125 MOCVD
- Veeco Propel Power MOCVD
- Veeco TurboDisc E450 LDM MOCVD
- Veeco TurboDisc E450 MOCVD
- Veeco TurboDisc E475 MOCVD
- Veeco TurboDisc EPIK 700 MOCVD
- Veeco TurboDisc K300 MOCVD
- Veeco TurboDisc K465 MOCVD
- Veeco TurboDisc K465i HP MOCVD
- Veeco TurboDisc K465i MOCVD
- Veeco TurboDisc K475 MOCVD
- Veeco TurboDisc K475i MOCVD
- Veeco TurboDisc MaxBright M MOCVD
- Veeco TurboDisc MaxBright MHP MOCVD
- АО «НИИТМ»
- АО «НТО»(SemiTEq®)
- ИФП им. А.В.Ржанова
- ФТИ им. А.Ф. Иоффе
- Мехобработка
- Оборудование
- Партнеры
- Планаризация
- Проектирование промышленных объектов
- Проектирование чистых помещений
- Реализованные объекты. Научные исследования
- Реализованные объекты. Радиоэлектронное приборостроение
- Реализованные объекты. Фотовольтаика, энергетика, материаловедение
- Реализованные объекты. Электронная промышленность
- Рост слитков
- Термобарокамеры (камеры пониженного давления)
- Термострессовые виброкамеры AST
- Термошоковые климатические камеры серии ATS
- Услуги
- ФГУП ЭЗАН
- Эпитаксия
- Контакты
© СКТО Промпроект 2001-2025
